8月21日,从江苏通用半导体有限公司传来消息,由该公司自主研发的国内首套的8英寸碳化硅晶锭激光全自动剥离设备正式交付碳化硅衬底生产领域头部企业广州南砂晶圆半导体技术有限公司,并投入生产。
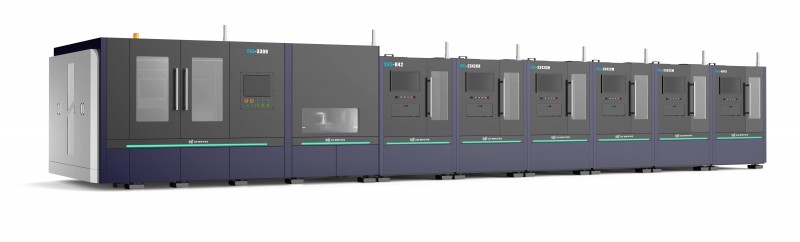
该设备可实现6英寸和8英寸碳化硅晶锭的全自动分片,包含晶锭上料、晶锭研磨、激光切割、晶片分离和晶片收集,一举填补了国内碳化硅晶锭激光剥离设备领域研发、制造的市场空白,突破了国外的技术封锁,将极大地提升我国碳化硅芯片产业的自主化、产业化水平。
该设备年可剥离碳化硅衬底20000片,实现良率95%以上,与传统的线切割工艺相比,大幅降低了产品损耗,而设备售价仅仅是国外同类产品的1/3。
近年来,碳化硅功率器件在大功率半导体市场中所占的份额不断提高,并被广泛应用于新能源汽车、城市轨道交通、风力发电、高速移动、物联网等一系列领域。
但是,由于材料的高硬度、高脆性的特点,在使用传统的砂浆线、金刚石线等冷切工艺切割、剥离碳化硅晶锭时,存在效率过低、损耗过高的缺点,导致衬底产能提升过慢,远远不能满足市场的实际需求。由于产能严重不足,碳化硅衬底的生产成本一直居高不下,在器件成本构成中,碳化硅器件中衬底要占成本的47%,远远高于硅基器件的7%。

来源:中国江苏网
应用终端 SIC IGBT模块 SIC模块 碳化硅衬底 IGBT芯片 分立器件 材料 焊接材料 真空回流焊炉 烧结银 烧银炉 烧结炉 陶瓷基板 铜底板 焊接设备 划片机 晶圆贴片机 灌胶机 贴片 表面处理 硅凝胶 环氧树脂 散热器 铝碳化硅 五金 键合机 键合丝 超声焊接机 陶瓷劈刀 激光设备 设备配件 PVD设备 ALD 电子浆料 CVD 导热材料 元器件 密封胶 X-Ray 配件 超声波扫描显微镜 塑胶外壳 玻璃 塑料 线路板 设备 散热材料 热敏电阻 点胶机 胶水 自动化设备 运动控制 封装设备 检测设备 认证检测 夹治具 清洗设备 测试设备 磨抛耗材 磨抛设备 代理 贸易 其他

