近日,深圳市矩阵多元科技有限公司(以下简称“矩阵多元科技”)宣布完成亿元B2轮融资,由中车资本、智慧互联产业基金、前海母基金和毅达资本联合投资,资金主要用于新一代先进封装PVD量产设备的研发、产能扩充以及补充流动资金等。已有股东还包括联想创投、中芯聚源、汇川产投、松禾资本、国中资本、中信建投资本等国内知名的产业及风险投资机构。
随着摩尔定律不断逼近物理极限,先进封装已成为“超越摩尔”的重要手段,面板级的大尺寸基板和玻璃基板的应用,有望引领先进封装技术进入一个全新的阶段。
扇出型面板级封装(Fanout Panel Level Package, FOPLP)是一种基于重新布线层(RDL)工艺,将芯片重新分布在大尺寸面板上进行互连的先进封装技术,能够将多个芯片、无源元件和互连集成在一个封装内,为封装行业提供了一种更大灵活性、扩展性和更低成本的解决方案,在AIoT、5G、自动驾驶等领域具有广阔前景。同时,AI驱动高阶算力芯片需求持续增长的背景下,FOPLP不仅能够容纳更多I/O数量大幅提升芯片效能,并且在大尺寸芯片封装应用较传统的晶圆级封装显著降低单位成本,包括NVIDIA、AMD在内的头部AI芯片企业也已积极布局。
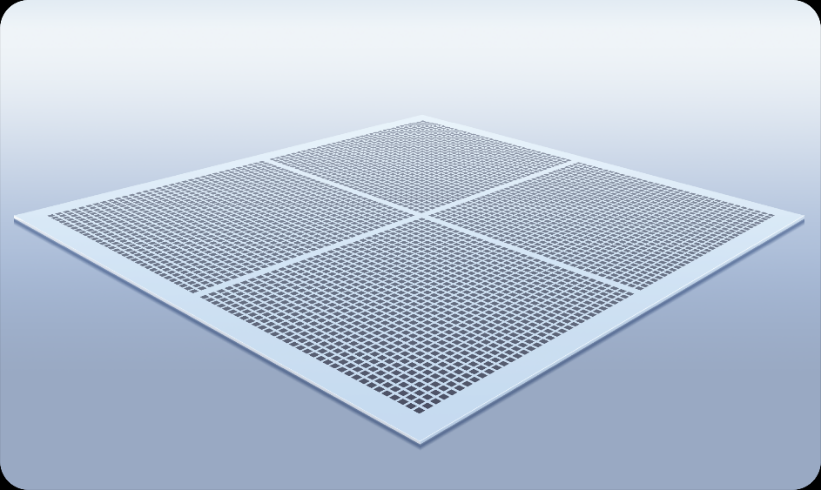 图:FOPLP封装(图片来源:奕成科技)
玻璃基板给先进封装带来了更大的想象空间。由于有机材料存在耗电量大、收缩和翘曲等限制,在使用有机材料的硅封装中,微缩晶体管的能力可能即将达到极限,而玻璃基板则可在线宽、线距、凸点尺寸等方面做到更加精细,有效提升互联密度等多方面性能,玻璃基板的应用有望帮助半导体行业在2030年之后仍然能够延续摩尔定律。
其中,玻璃通孔(Through Glass Via, TGV)在诸多应用领域可以颠覆硅通孔(Through Silicon Via, TSV),并可替代传统的硅中间层。玻璃基板具有不易变形(有机基板易翘曲)、更高效的数据/信号/能量传输、更高的芯片集成度(可在相同的封装尺寸下提升50%的芯粒Die容量)、可直接与光通讯计算集成等优势,有助于半导体产业“超越摩尔定律”,代表下一代高性能芯片先进封装领域的发展方向。
图:FOPLP封装(图片来源:奕成科技)
玻璃基板给先进封装带来了更大的想象空间。由于有机材料存在耗电量大、收缩和翘曲等限制,在使用有机材料的硅封装中,微缩晶体管的能力可能即将达到极限,而玻璃基板则可在线宽、线距、凸点尺寸等方面做到更加精细,有效提升互联密度等多方面性能,玻璃基板的应用有望帮助半导体行业在2030年之后仍然能够延续摩尔定律。
其中,玻璃通孔(Through Glass Via, TGV)在诸多应用领域可以颠覆硅通孔(Through Silicon Via, TSV),并可替代传统的硅中间层。玻璃基板具有不易变形(有机基板易翘曲)、更高效的数据/信号/能量传输、更高的芯片集成度(可在相同的封装尺寸下提升50%的芯粒Die容量)、可直接与光通讯计算集成等优势,有助于半导体产业“超越摩尔定律”,代表下一代高性能芯片先进封装领域的发展方向。
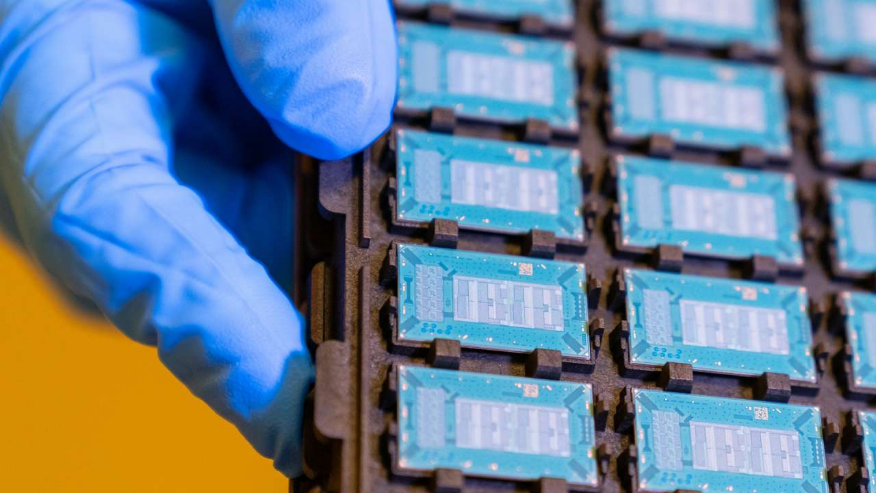 图:玻璃基板封装芯片(图片来源:Intel)
传统有机材料基板和TSV目前面临着制造成本高、工艺控制难度大、热管理问题突出、高频损耗大、集成密度相对低等难以解决的问题,玻璃基板和TGV则有望克服这些挑战,将芯片设计、制造提升到新的水平。
矩阵多元科技目前聚焦于半导体先进封装的薄膜沉积工艺,已掌握国际尖端的磁控溅射PVD设备关键技术,具有整机机台的设计、生产和交付能力,并自主研发出溅射阴极系统、面板级封装基片装载系统等多项关键子系统。
矩阵多元科技的工业级量产设备DEP600(双枚叶式先进封装溅射PVD设备)应用于扇出型面板级封装中的种子层金属化,已经获得数个国内头部半导体封装厂商订单,打破了核心关键设备的国际垄断。
同时,基于DEP600平台,矩阵多元科技已经完成用于高深宽比玻璃通孔(TGV)种子层金属化的PVD设备样机搭建,正在为多家意向客户进行打样测试。
矩阵多元科技核心技术团队来自于国际一线的半导体龙头企业,曾获得深圳市高层次人才团队研发资助,其设备多次入选广东省、深圳市首台套重大技术装备推广应用指导目录。
图:玻璃基板封装芯片(图片来源:Intel)
传统有机材料基板和TSV目前面临着制造成本高、工艺控制难度大、热管理问题突出、高频损耗大、集成密度相对低等难以解决的问题,玻璃基板和TGV则有望克服这些挑战,将芯片设计、制造提升到新的水平。
矩阵多元科技目前聚焦于半导体先进封装的薄膜沉积工艺,已掌握国际尖端的磁控溅射PVD设备关键技术,具有整机机台的设计、生产和交付能力,并自主研发出溅射阴极系统、面板级封装基片装载系统等多项关键子系统。
矩阵多元科技的工业级量产设备DEP600(双枚叶式先进封装溅射PVD设备)应用于扇出型面板级封装中的种子层金属化,已经获得数个国内头部半导体封装厂商订单,打破了核心关键设备的国际垄断。
同时,基于DEP600平台,矩阵多元科技已经完成用于高深宽比玻璃通孔(TGV)种子层金属化的PVD设备样机搭建,正在为多家意向客户进行打样测试。
矩阵多元科技核心技术团队来自于国际一线的半导体龙头企业,曾获得深圳市高层次人才团队研发资助,其设备多次入选广东省、深圳市首台套重大技术装备推广应用指导目录。

原文始发于微信公众号(联想创投):专注新一代先进封装PVD解决方案,被投企业「矩阵多元」完成亿元B2轮融资丨 LCIG Portfolio
先进封装设备类似前道晶圆制造设备,供应商受益先进封测产业增长。随着先进封装的发展,Bumping(凸块)、Flip(倒装) 、TSV 和 RDL(重布线)等新的连接形式所需要用到的设备也越先进。以长球凸点为例,主要的工艺流程为预清洗、UBM、淀积、光刻、焊料 电镀、去胶、刻蚀、清洗、检测等,因此所需要的设备包括清洗机、PVD 设备、光刻机、 刻蚀机、电镀设备、清洗机等,材料需要包括光刻胶、显影剂、刻蚀液、清洗液等。为促进行业发展,互通有无,欢迎芯片设计、晶圆制造、装备、材料等产业链上下游加入艾邦半导体先进封装产业链交流群。

我们诚邀您加入“玻璃基板与TGV技术交流群”,与行业精英共同探讨玻璃基板及TGV技术的前沿动态,共享资源,交流经验。在这里,您可以第一时间获取技术革新信息,深入解析行业趋势,与行业领袖面对面交流,共同推动技术革新,探索无限商机。

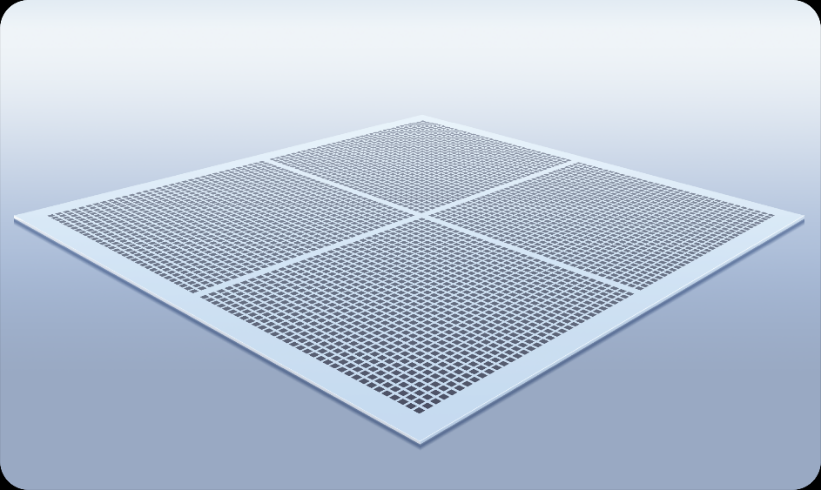 图:FOPLP封装(图片来源:奕成科技)
图:FOPLP封装(图片来源:奕成科技)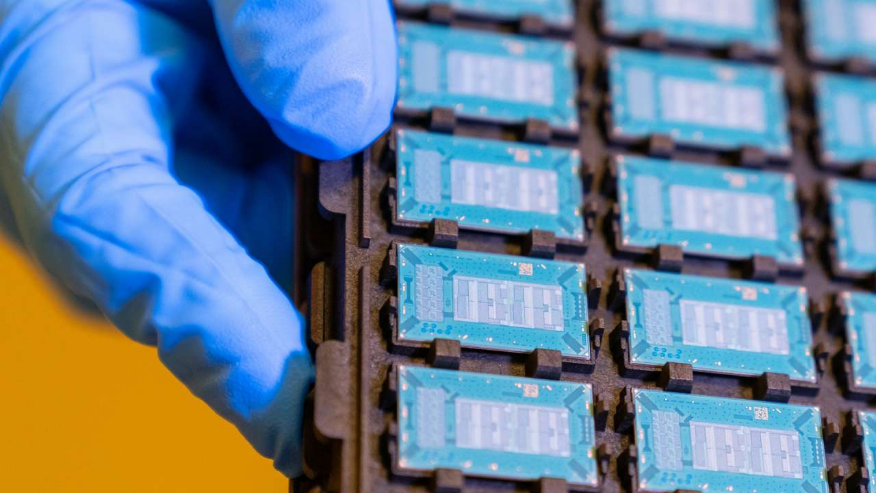 图:玻璃基板封装芯片(图片来源:Intel)
图:玻璃基板封装芯片(图片来源:Intel)






