集成电路产业的发展需要依靠制造工艺技术的进步,使芯片关键尺寸(Critical Dimension,CD)不断缩小,从而令器件集成度增加、成本下降、功耗降低、性能提高。如图所示,集成电路制造工艺主要包含晶圆准备、沉积、光刻(Optical Lithography)、刻蚀等步骤,制造一片先进的处理器芯片通常需要经过上千道工序,多次重复以上步骤。
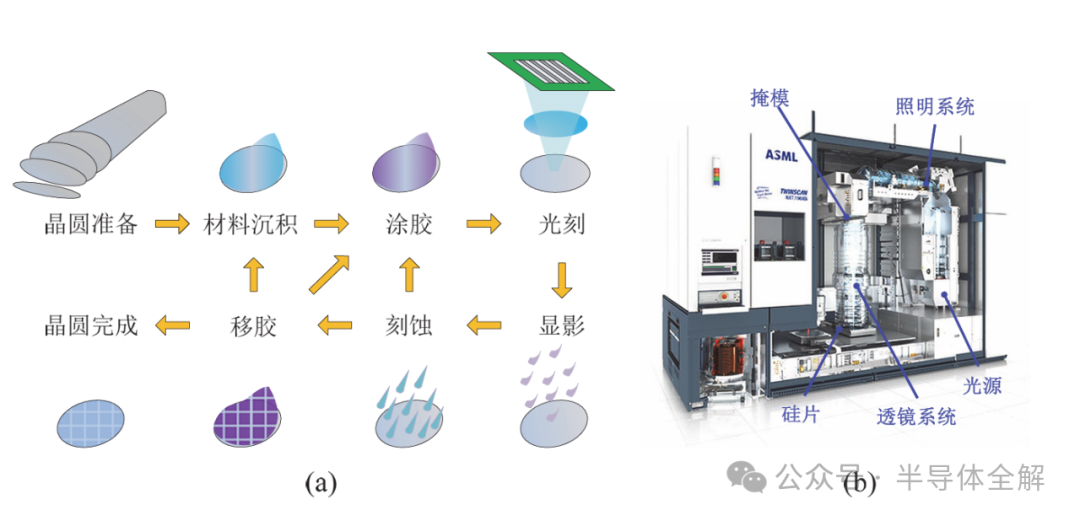
其中,光刻工艺最为关键,它的任务是将掩模图形转移到涂敷于硅片的光刻胶上,它代表了制造工艺的先进程度,直接决定能够制造的最小图形尺寸。上图是荷兰ASML公司的一台光刻机,从物理本质上看,光刻系统可以简化成由照明光源、掩模、投影物镜系统、以及涂覆在硅片上的光刻胶四个基本要素组成。
照明光源发出的光经过照明系统,穿过掩模中的透明部分,进入投影物镜系统,在光刻胶上成像,接触光的光刻胶物理化学性质发生改变,从而将掩模图形信息转移到光刻胶上,最后通过显影、刻蚀等后续工艺将图形转移到硅片(基底)上。
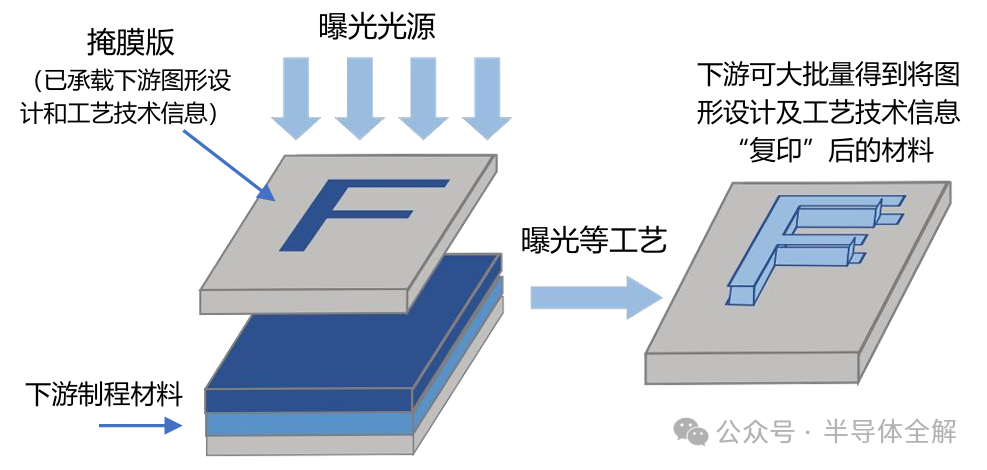
掩膜版又称光罩、光掩膜、光刻掩膜版等,是微电子制造过程中的图形转移工具或母版,是承载图形设计和工艺技术等知识产权信息的载体。
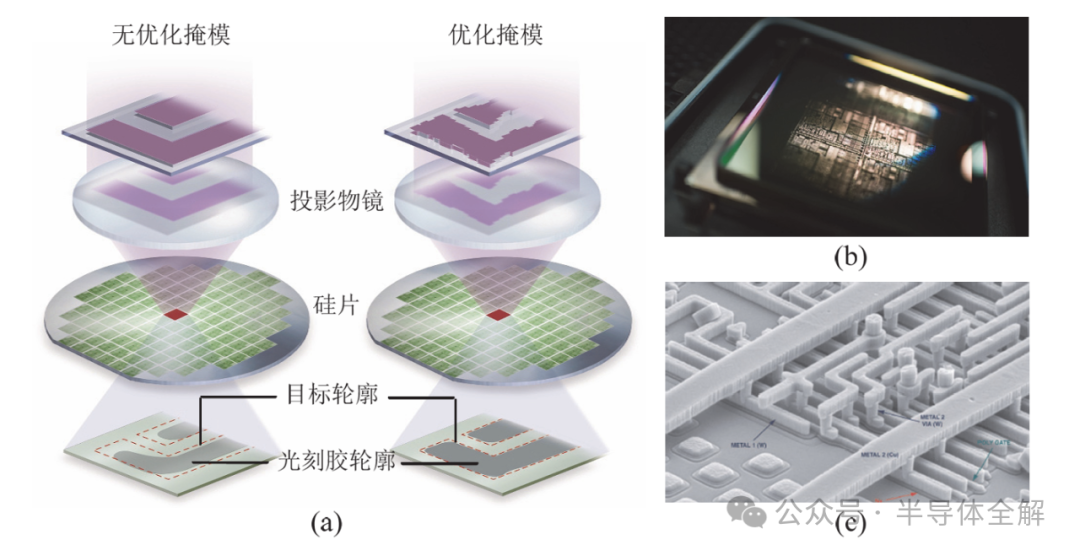
根据客户所需要的图形,掩膜版厂商通过光刻制版工艺,将微米级和纳米级的精细图案刻制于掩膜版基板上(掩膜版的原材料掩膜版基板是制作微细光掩膜图形的感光空白板),随后再将不需要的金属层和胶层洗去,即得到掩膜版产成品。掩膜版对下游行业生产线的作用主要体现为,利用掩膜版上已设计好的图案,通过透光与非透光的方式进行图像(电路图形)复制,从而实现批量生产。
作为光刻复制图形的基准和蓝本,掩膜版是连接工业设计和工艺制造的关键,掩膜版的精度和质量水平会直接影响最终下游制品的良率。
掩膜版的功能类似于传统照相机的“底片”:将设计者的电路图形通过曝光的方式转移到下游行业的基板或晶圆上,从而实现批量化生产。作为光刻复制图形的基准和蓝本,掩膜版是连接工业设计和工艺制造的关键,掩膜版的精度和质量水平会直接影响最终下游制品的优品率。掩模版是光刻工艺中的关键耗材,对于光刻工艺的重要性不弱于光刻机、光刻胶。
当芯片关键尺寸达到照明光源波长以下,光波穿过掩模时,光学衍射等光学临近效应(Optical Proximity Effects)变得非常显著,致使掩模的光学像产生畸变,从而使掩模图形在转移到光刻胶上时并不与掩模本身完全相同。
当芯片的关键尺寸远大于照明光源波长的时候,掩模在光刻胶面所成的光学像与掩模本身图形一致。因此直接将需要的光刻胶图形,即目标图形,制作成掩模图形,就可以满足生产的需求;当芯片关键尺寸接近或者小于照明光源波长时,光学临近效应显著,直接将目标图形作为掩模进行曝光会导致它的光刻胶图形与目标图形相比有很大的误差,如下图所示。
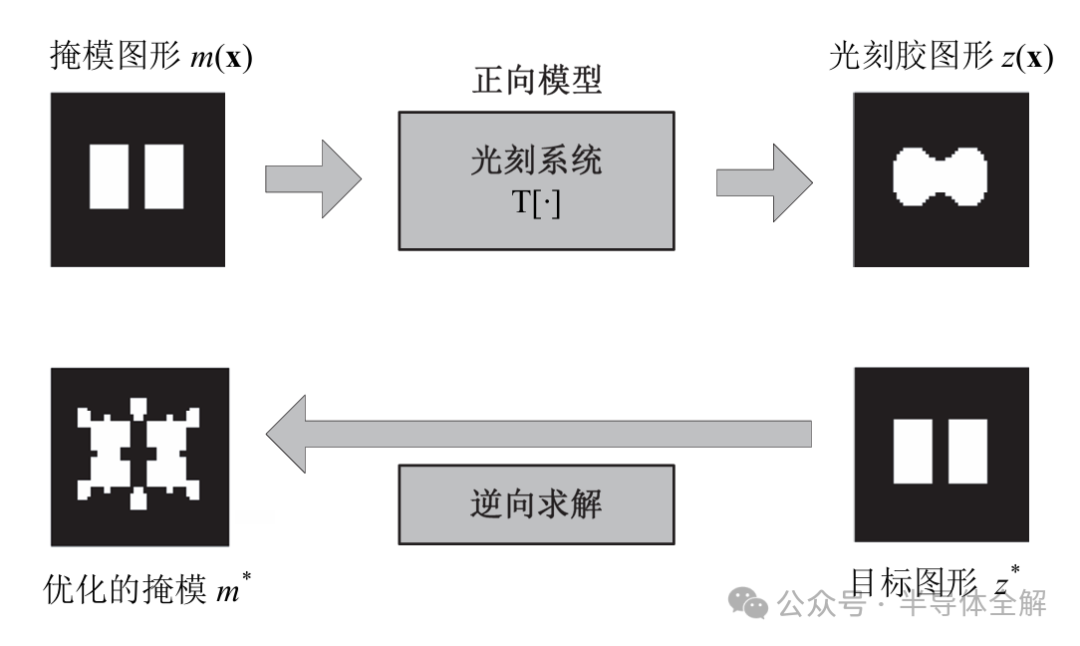
因此,当芯片关键尺寸在波长尺度时,需要根据目标图形对掩模进行重新设计。基于像素表征的掩模设计中,掩模被离散成一幅包含若干个网格的栅格图像,每个网格的透过率用一个像素点的灰度值来表征。通常它被描述成一个逆向问题,即已知需要的光刻胶图形求解相应的掩模图形。
光罩是连接芯片设计和生产的纽带。通常光罩表面的图形我们称作layout,这是由design部门设计出来的,我们称为PreOPC。设计好以后,会发送给OPC部门进行处理,OPC处理完后发送给光罩厂的数据叫做PostOPC。OPC(Optical Proximity Correction)部门。翻译就叫光学邻近修正。这是光罩部门最核心的部门。
简单解释一下:由于光罩本身是由石英基板和遮光材料制作,具有一定的厚度。虽然石英的穿透率几乎100%,但在纳米尺度上,光线穿透光罩发生的衍射等效应仍然无法避免,严重影响曝光出pattern的质量,这一系列偏差被称作光学邻近效应。光学邻近修正是通过计算光刻软件进行曝光模拟,目的是模拟出光刻机的曝光过程,最小化光学邻近效应,使曝光出来的图形无限接近于设计图形,行内术语叫meet target。
OPC部门通常有以下几个工种:RET(Resolution Enhancement Tech)分辨率提升技术(有的公司可能不这么说)、Model 和Recipe。简单的说RET的主要工作内容就是通过CD-SEM机台测量收集不同条件下的光罩曝光数据,然后交给Model工程师建立光学模型,最后Recipe工程师使用计算光刻软件导入光学模型,进行最后的光学邻近修正。这里面Model岗位是技术含量最高的,他们需要考虑不同参数对光刻的影响,比如focus,dose,光刻胶的种类,光刻机光源等等,结合实际不断对光学模型进行优化;Recipe工程师次之,主要是通过代码口令选择不同特征的图形,对需要修正的部位进行修正,而修正的手段各异。因为Recipe是OPC的最后一道关,而fab跑货十分注重时间效率,因此delay是大忌。因此如何在有限的时间内把OPC修到最完美,这也是一个十分有挑战性的工作;最后就是收集CD的岗位了,就是比较程序化的工作。OPC修正完之后,数据就交给了MDP(Mask Data Preparation,有的公司也有他称)光罩数据转换工程师。这个岗位的工作内容就比较简单了,就是把OPC修正好的数据(PostOPC)转换成为光罩厂可以使用的格式。检查无误后发送给光罩厂制作即可。因此这个岗位深得女生的喜爱,一般没有特殊情况可以保证朝九晚五。另外还有 MKL(Mask Kerf Layout)工程师,就是画光罩上的一些标记(mark)。
Mark的种类不一而足,比如overlay mark,alignment mark等等,一句话概括,这一系列标记都是为了光刻过程中的层叠和对准(要知道芯片全流程需要几十上百道layer,如果每个layer的对准精度不够,层层叠加,到最后就wafer就直接报废了)。当然MKL部门自己并不需要知道为什么画成那样,都是需求部门提出要求,他们照着做就好了。最后就是MM(Mask Management)。这就是直接接触产线的光罩管理部门了,光罩厂制作好后,光罩快递过来到fab后所有涉及光罩使用都由他们负责处理。

1)基板:分为树脂基板和玻璃基板,玻璃基板主要包括石英基板和苏打基板;
2)遮光膜根据种类的不同,可以分为乳胶和硬质遮光膜。
光掩膜按用途分类可分为铬版、干版、液体凸版和菲林。其中,铬版精度最高,耐用性更好,广泛应用于平板显示、IC、印刷线路板和精细电子元器件行业;干版、液体凸版和菲林主要用于中低精度LCD行业、PCB及IC载板等行业。
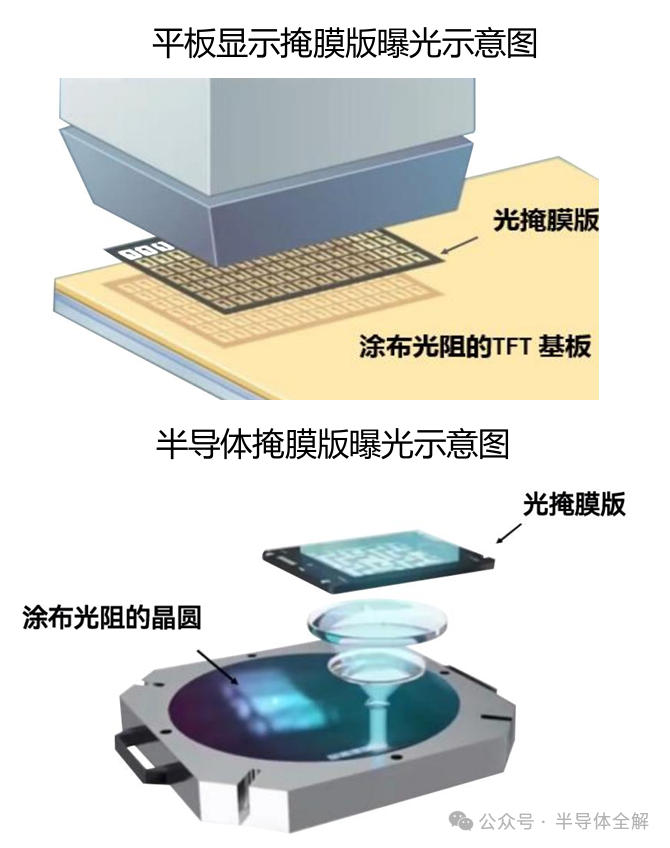
掩膜版最重要的原材料是掩膜基板,光掩膜基板作为掩膜版图形的载体,对掩膜版产品的精度和品质起到重要作用。根据基板材料的不同,掩模版厂商的主要原材料为石英基板、苏打基板和光学膜等。
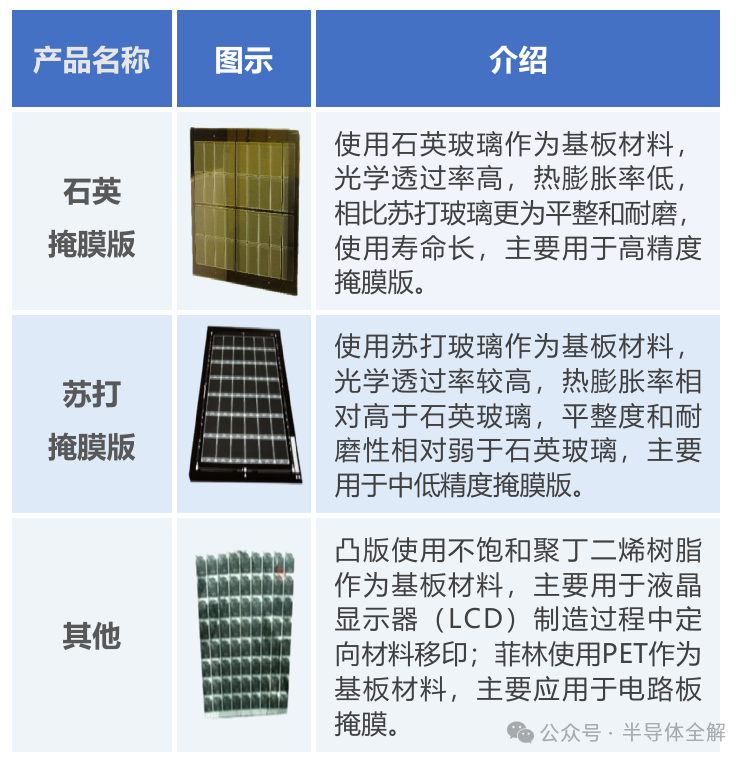
石英基板和光学膜技术难度较大,供应商主要集中于日本、中国台湾等地,原材料存在一定的进口依赖。
目前所使用的掩模版衬底材料合成石英占比最大。被用来制作光掩膜版的玻璃包括合成石英、硼硅玻璃和苏打玻璃,其中合成石英最为化学稳定,具有高硬度、低膨胀系数和透光性强等优势,适用于较高精度要求的产品生产,广泛应用于LSI 用光掩膜、FPD 用大型掩膜的制造。但是石英成本高,现在倾向于发展高质量的合成石英材料,它能够提供宽的光投射区域、低的杂质含量和少的物理缺陷,并且随着低膨胀率和深UV 的要求变得逐渐广泛。
石英玻璃在透光率以及化学性能上优于其余掩膜基材。通常温度和湿度的改变将引起材料一定程度上的形变,从而造成掩膜板上图像的细小位移及线宽的改变。石英玻璃由于其在热膨胀和硬度等物理属性上的优势,使得它对自然环境的影响如温度,湿度,压力有比较大的容忍性。这意味着石英掩膜板能保持化学性质稳定和在特定波长光源照射下的高穿透度。
遮光膜材料主要包括:金属铬、硅、氧化铁、硅化钼等,遮光膜材料的选择主要取决于产品的图形精度、透过率、耐化学品性能等因素。其中,铬是最常用的遮光膜材料,根据不同的层数,可以应用于投影曝光机用光掩膜、LSI 用光掩膜、FPD 用光掩膜和Stepper用Reticle 等领域。但是铬也有一些缺点,如反射率高和膜形成工艺复杂等。硅是一种See Through 型的遮光膜材料,适合手动对位操作,但其微加工性能不如铬,因此只用于低端硬质光掩膜。氧化铁和硅化钼是两种特殊的遮光膜材料,前者没有明显的优缺点,后者具有Half Tone 特性优异的优点,但耐化学品性能差,主要用于LSI 用Half Tone Mask。
掩膜版制造商分为两种,一种是英特尔、台积电、中芯国际等代工厂拥有自制掩膜版业务,其产能基本都是自产自销;另一种就是独立于代工厂的第三方掩膜版制造商,例如美国福尼克斯、日本DNP、凸版印刷,以及中国大陆的清溢光电、路维光电等,这类厂商主要销售的是成熟制程掩膜版。
根据光刻工艺所用到的不同光源,常见的掩膜版大致分为:二元掩膜版、相移掩膜版、EUV 掩膜版。
1、二元掩膜版是指由透光与不透光两种部分组成的光掩模版,是最早出现、也是使用最多的一类掩模版,被广泛用于365nm(I 线)至193nm 的浸没式光刻。
2、相移掩膜版是指在相邻的透光缝隙处设置厚度与1/2 光波长成正比的相移层的掩膜产品。这种产品的诞生主要由于集成电路设计的高速发展,设计图形的尺寸日益缩小所导致的光学邻近效应越来越明显以及由于曝光波长的短化在改善清晰度的同时会减少焦点深度,进而降低工艺过程的稳定性。因此,为了保证光刻图形的精确性以及保持焦点深度,相移掩模技术被越来越多的采用。相移掩膜技术使透过相移层的曝光光线与其他透射光产生180 度的光相位差,使在相邻透光缝隙中间点上的光强互相抵消或减弱,进而控制光的相位及透过率,改善对晶圆曝光时的分辨率及焦点深度,最终提高了复刻特性的光掩模。
3、EUV 掩膜版是指在EUV 光刻期间使用的新颖掩膜版。由于EUV 的波长很短,容易被所有材料吸收,因此不能使用像透镜这样的折射元件而是根据布拉格定律通过多层(ML)结构来反射光束。EUV 掩膜版常用于7nm、5nm等先进制程,所以EUV 掩膜版的工艺问题会非常难以发现并且十分致命。
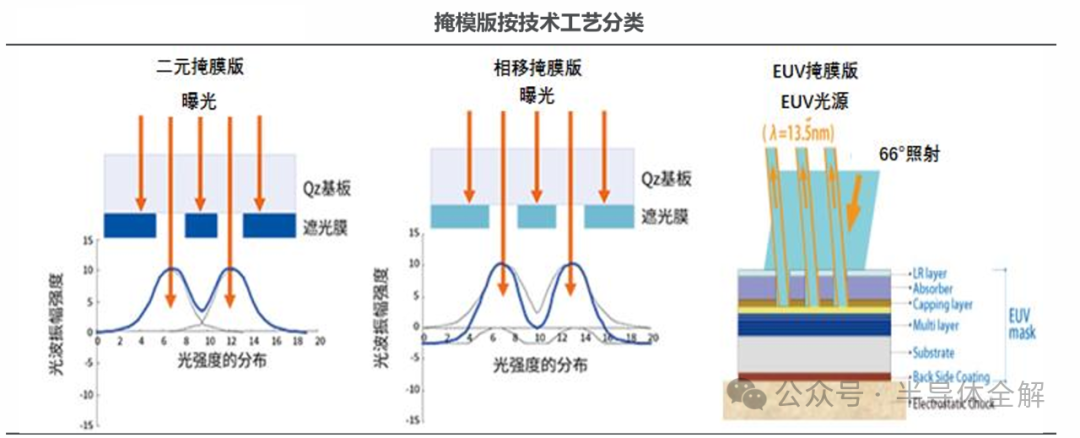
关于掩膜版的介绍就到这儿,喜欢半导体技术相关的朋友可以阅读其他相关文章!
参考文献:
(1)吕稳 基于像素表征的光刻掩模优化方法研究[D].
(2)张晓蕾 超声提高SU-8光刻胶_金属基底界面结合强度研究[D].
(3)尚红波 浸没光刻投影物镜光学设计与像差补偿研究[D].
(4)华福证券 光刻机行业深度报告:博采众星之光,点亮皇冠明珠[C].
(5)民生证券 掩膜版行业深度报告:光刻蓝本亟待突破,国产替代大有可为[C].
原文始发于微信公众号(半导体全解):一文了解光刻掩膜版(光罩)技术