4月14日,肖特集团宣布成功完成其历史上规模最大的收购,德国尖端科技企业QSIL GmbH Quarzschmelze Ilmenau正式加入肖特。此次收购将高性能石英玻璃 -- 微芯片制造的关键材料 -- 融入肖特的特种材料矩阵。
行业数据显示,用于先进芯片封装的玻璃基板在高性能计算中,使芯片性能最高可提升40%,同时极大减少能源消耗。
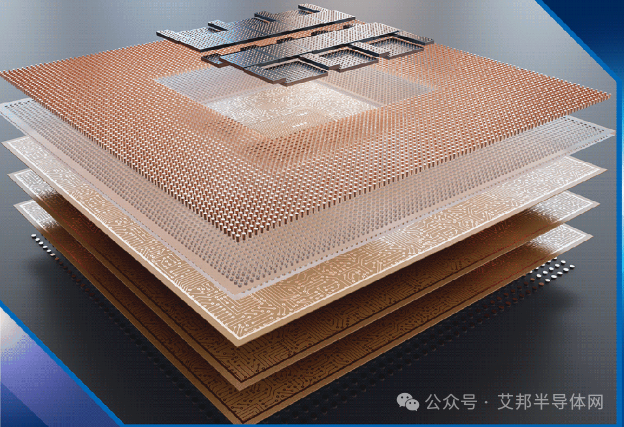
IC基板和互插件可使用玻璃代替聚合物或硅片,对于芯片和无源组件的高密度互连至关重要。肖特玻璃板具有多种热膨胀系数(CTE)特性,提供出色的耐热性和耐化学性,是微结构化和金属化的理想选择。高品质的玻璃原材料以及可供选择的多热膨胀系数(CTE)范围,有助于实现芯片集成封装的工艺制程和精度。
相比于硅基转接板,玻璃通孔(TGV)技术不仅具备更低的制造成本、更简化的工艺流程,还在实现微型化与高可靠性设备方面展现出巨大潜力。肖特HermeS®玻璃通孔(TGV),可实现晶圆级芯片尺寸(WLCSP)级别的全密封。Hermes®TGV具有卓越的可靠性、出色的射频性能、极高的光学透明性,在半导体领域有广泛应用。
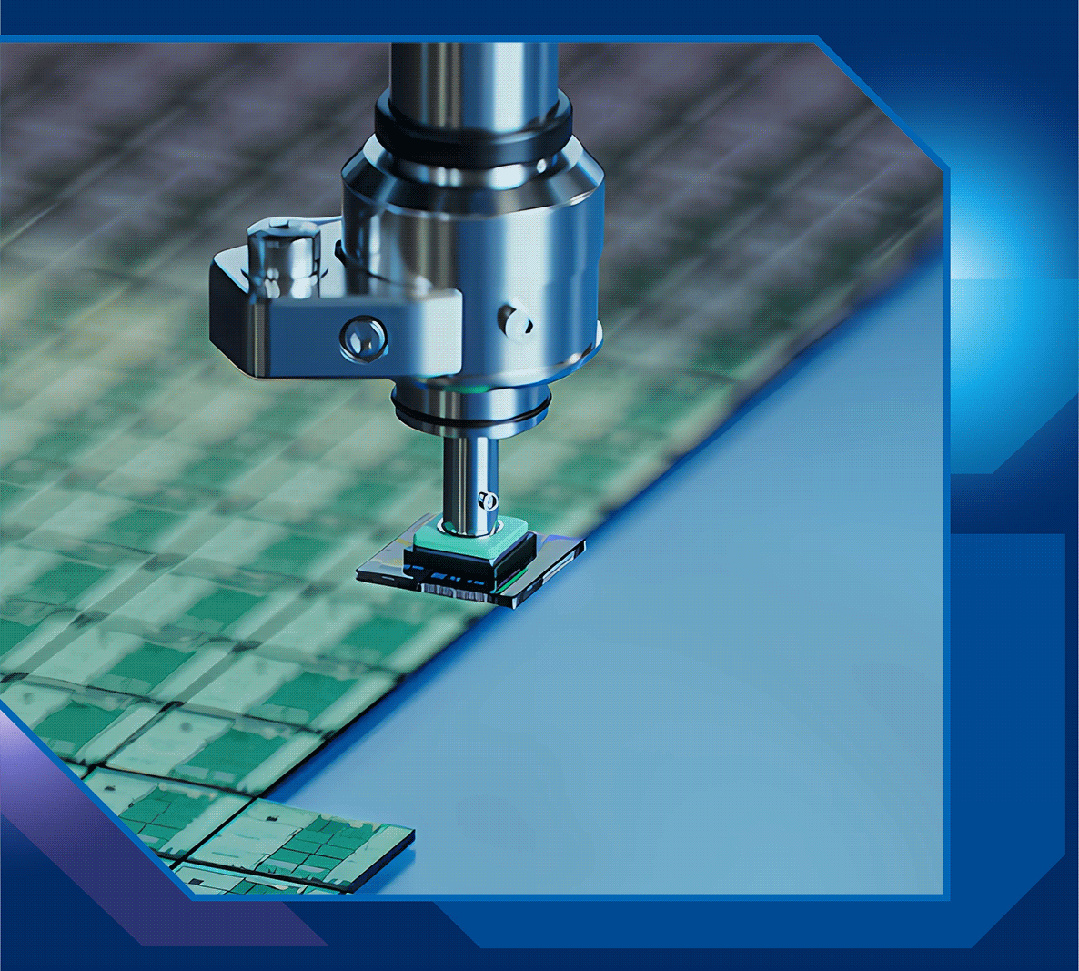
得益于其优异的内在特性,玻璃可以精确匹配制造过程和设备所需的热膨胀系数。同时,其机械耐久性和化学稳定性优于传统基板材料。在3DIC封装领域,玻璃载板使芯片堆鲁高度集成成为可能;面对扇出晶圆级封装(FO-WLP)和面板级封装(PLP)的需求,其卓越的几何精度允许同时处理更大尺寸基板或多芯片阵列。
在中国,肖特在苏州建立了半导体先进封装玻璃解决方案专属团队。从材料研发定制解决方案到量产落地,肖特构建起完整的创新与供应链条。
来源:肖特集团官微
艾邦建有玻璃基板与TGV技术交流群,可以加强产业链的合作,促成各企业的需求对接,同时您也可以与行业精英共同探讨玻璃基板及TGV技术的前沿动态,共享资源,交流经验,欢迎您的加入。

活动推荐一:第二届玻璃基板TGV产业链高峰论坛(8月26-27日 深圳)




