
壹 第三代半导体
第一代半导体技术基于Si、Ge等半导体材料发展而来,是发展晶体管、集成电路技术的物质基础,第一代半导体材料奠定了20世纪电子工业的基础,是集成电路技术的基础材料。
第二代半导体材料主要包括砷化镓、磷化铟、磷化镓、砷化铟、砷化铝及其三元化合物,第二代半导体材料是光电信息产业的基础,在此基础上发展起了照明、显示、激光、光伏等相关产业,在当代信息技术和光电显示产业应用广泛。
第三代半导体材料的代表性材料包括氮化镓、碳化硅等,由于其宽带隙、高电子饱和漂移速度、高热导率、大击穿场强等优势,是制备高功率密度、高频率、低损耗电子器件的理想材料。其中碳化硅功率器件具有能量密度高、能耗小、体积小的优势,在新能源汽车、光伏、轨道交通、大数据等领域具有广阔的应用前景。氮化镓射频器件具有高频、高功率、较宽频带、低功耗、小尺寸的优势,在5G通信、物联网、军用雷达等领域具有广泛的应用前景。此外,氮化镓基功率器件已广泛应用到了低压领域。除此之外,近年来新兴的氧化镓材料有望与现有的SiC及GaN技术形成技术互补,在低频、高压领域具有潜在应用前景。
与第二代半导体材料相比,第三代半导体材料具有禁带宽度更宽(第一代半导体材料的典型材料Si的禁带宽度约1.1eV,第二代半导体材料典型材料GaAs的禁带宽度约1.42eV,第三代半导体材料典型的GaN禁带宽度在2.3eV以上)、抗辐照能力更强、抗电场击穿能力更强、更耐高温等特点。具有更宽禁带宽度的第三代半导体材料特别适合制作抗辐照、高频、大功率和高集成密度的电子器件,在微波射频器件、LED、激光器、功率器件等领域的应用备受瞩目,在移动通信、智能电网、轨道交通、新能源汽车、消费电子以及紫外和蓝绿光器件等领域展现出广阔的发展前景[1]。

图片来源:CASA,浙商证券研究所
图表 1 GaN功率器件时长规模及预测
贰 GaN材料结构及特性
GaN是直接带隙半导体,室温下纤锌矿结构的禁带宽度约3.26eV。GaN材料主要有三种晶体结构,分别为纤锌矿结构、闪锌矿结构和岩盐矿结构。其中,纤锌矿结构是最稳定的晶体结构。图2是GaN的六方纤锌矿结构图,纤锌矿结构的GaN材料属于六方密堆积结构,每个晶胞都有12个原子,其中包括6个N原子和6个Ga原子,每个Ga(N)原子都与最近邻的4个N(Ga)原子成键,沿[0001]方向按照ABABAB…顺序堆积[2]。

图表 2 纤锌矿结构GaN晶胞图
叁 GaN外延常用衬底
看似在GaN衬底上进行同质外延是GaN外延的最优选择,然而由于GaN的键能较大,在温度达到熔点2500℃时,其对应的分解压约4.5GPa,当分解压低于该压力时,GaN不熔化,而是直接分解,这就使得提拉法等成熟的衬底制备技术不适于GaN单晶衬底的制备,导致GaN衬底难以大规模生产,且成本较高,因此目前GaN外延生长中经常用到的衬底主要有Si、SiC、蓝宝石等[3]。

图表 3 GaN与常用衬底材料的参数
蓝宝石上的GaN外延
蓝宝石化学性质稳定,且价格便宜,规模化生产产业成熟度高,因此成为半导体器件工程中最早取得应用,也是应用广泛的衬底材料之一,作为GaN外延的常用衬底之一,蓝宝石衬底需要解决的主要问题有:
✔ 由于蓝宝石(Al2O3)与GaN的晶格失配较大(约15%),导致外延层和衬底界面处的缺陷密度非常高,为了减少其不利影响在外延过程开始前必须对衬底进行繁复的前处理,在蓝宝石衬底上生长GaN外延前,首先需经过严格的清洗处理衬底表面,以除去污染物、残留的抛光损伤等,并产生台阶和台阶表面结构,然后对衬底表面进行氮化以改变外延层的润湿特性,最后还需要在衬底表面沉积一层薄的AlN缓冲层(通常为10-100nm厚),并经过低温退火,以为最终的外延生长做准备。即使如此,与同质外延相比,蓝宝石衬底上生长的GaN外延膜中位错密度依然较高(约1010cm-2与之相比,硅同质外延或砷化镓同质外延的位错密度基本上为零,或在102到104cm-2之间),较高的缺陷密度降低了载流子迁移率,进而缩短了少子寿命,并降低了热导率,这些都会降低器件性能[4];
✔ 蓝宝石的热膨胀系数大于GaN,因此在从沉积温度降低至室温的过程中外延层内将产生双轴压缩应力。对于膜厚较厚的外延膜,该应力可能导致薄膜甚至衬底开裂;
✔与其他衬底相比,蓝宝石衬底热导率较低(100℃时约0.25W*cm-1*K-1),散热性能较差;
✔蓝宝石衬底由于导电性较差,对其与其他半导体器件的集成和应用不利。
尽管在蓝宝石衬底上生长的GaN外延层缺陷密度较高,但其似乎并未明显降低GaN基的蓝绿光LED大的光电性能,因此蓝宝石衬底仍然是GaN基LED的常用衬底。
随着更多GaN器件如激光器或其他高密度功率器件等新型应用的发展,蓝宝石衬底的固有缺陷,对其应用的限制日益凸显,此外随着SiC衬底生长技术的发展、成本降低和Si衬底上GaN外延技术的发展成熟,对蓝宝石衬底基础上生长GaN外延层的更多研究已逐渐呈现出降温趋势。
SiC上GaN外延
与蓝宝石相比,SiC衬底(4H-和6H-晶型)与GaN外延层晶格失配程度较小(3.1%,相当于[0001]取向的外延膜),热导率更高(约3.8W*cm-1*K-1)等,此外,SiC衬底的导电性也使得可以在衬底背面制作电气接触,有助于简化器件结构。这些优点的存在吸引着越来越多的研究人员投入碳化硅衬底表面GaN外延的工作。
然而直接在SiC衬底避免生长GaN外延层工作同样面对一些列不利方面,其中主要有:
✔ SiC衬底远高于蓝宝石衬底的表面粗糙度(蓝宝石粗糙度0.1nm RMS,SiC粗糙度1nm RMS),SiC衬底硬度高,加工性能差,这种粗糙度和残留的抛光损伤也是GaN外延层中缺陷的来源之一。
✔ SiC衬底螺位错密度高(位错密度103-104cm-2),螺位错可能传播到GaN外延层并降低器件性能;
✔ 衬底表面原子排布诱导GaN外延层中形成堆垛层错(BSFs),对于SiC衬底上外延GaN,衬底上有多种可能得原子排列次序,导致其上外延GaN层初始原子堆垛次序不统一,容易产生堆垛层错。堆垛层错(SFs)沿c轴引入内建电场,导致面内载流子分离器件漏电等问题出现;
✔ SiC衬底的热膨胀系数小于AlN和GaN,使外延层和衬底间在降温过程中产生热应力集聚, Waltereit和Brand根据他们的研究成果预测,这一问题可以通过在薄的、相干应变的AlN成核层上生长GaN外延层来缓解或解决;
✔ Ga原子浸润性差问题,直接在SiC表面生长GaN外延层时,由于两者原子间浸润性差,GaN在衬底表面容易呈现3D岛状生长,引入缓冲层是GaN外延中改善外延材料质量的最常用方案,引入AlN或AlxGa1-xN缓冲层能够有效改善SiC表面浸润,使GaN外延层呈二维生长,此外还能够起到调控应力、阻挡衬底缺陷向GaN外延延伸的效果;
✔ SiC衬底制备技术不成熟,衬底成本高,且供应商较少,供应少。
Torres等的研究表明, 在外延前首先利用H2在高温(1600℃)下对SiC衬底进行蚀刻预处理,可以在衬底表面产生更有序的台阶结构,从而获得比在原始衬底表面直接生长时,更高质量的AlN外延薄膜。Xie及其团队的研究也表明,通过对碳化硅衬底的刻蚀预处理,能够明显提升GaN外延层的表观形貌和晶体质量。Smith等人发现,源于衬底/缓冲层和缓冲层/外延层界面的穿透位错与衬底的平整度有关[5]。

图表 4 不同表面处理情况下6H-SiC衬底(0001)面生长GaN外延层样品的TEM表观形貌(a)化学清洁;(b)化学清洁+氢等离子处理;(c)化学清洁+氢等离子处理+1300℃氢气热处理30min
Si上GaN外延
与碳化硅、蓝宝石等衬底相比,硅衬底制备工艺成熟,可以稳定提供成熟的大尺寸衬底,性价比高,同时导热导电性良好,且Si电子器件工艺成熟,未来有望将光电GaN器件与Si电子器件完美集成的可能性也使得在硅上生长GaN外延极具吸引力。
但同时,由于Si衬底与GaN材料晶格常数差异较大,以Si为衬底异质外延GaN是典型的大失配外延,也需要面对一系列问题:
✔ 表面界面能问题。当GaN生长在Si衬底上时,Si衬底表面会先氮化形成不利于高密度GaN成核生长的非晶氮化硅层,而且Si表面会先与Ga接触,Ga会腐蚀Si衬底表面,高温下Si表面分解会扩散进入GaN外延层形成黑色硅斑。
✔ GaN与Si之间晶格常数失配较大(~17%),这将导致高密度穿透位错形成,并显著降低外延层质量;
✔ 与Si相比,GaN的热膨胀系数更大(GaN的热膨胀系数约5.6×10-6K-1,Si的热膨胀系数约2.6×10-6K-1),在外延温度冷却至室温的过程中可能会在GaN外延层中产生裂纹;
✔ Si与NH3在高温下反应形成多晶SiNx。AlN无法在多晶态SiNx上形成择优取向的晶核,从而导致后续生长的GaN层取向混乱,缺陷非常高,导致GaN外延层晶体质量很差,甚至难以形成单晶GaN外延层[6]。
针对晶格失配大的问题,研究人员尝试在Si衬底上引入AlAs、GaAs、AlN、GaN、ZnO、SiC等材料作为缓冲层,为了避免多晶SiNx的形成,降低其对GaN/AlN/Si(111)材料晶体质量的不利影响在外延生长AlN缓冲层之前通常需要预通入一定时间TMAl以阻止NH3与裸露的Si表面接触发生反应形成SiNx。此外还可利用图形化衬底技术等外延技术改善外延层质量。这些技术的开发有助于抑制外延界面处形成SiNx,促进GaN外延层的二维生长,并提高外延层生长质量。此外,引入AlN缓冲层来补偿由于热膨胀系数的差异引起的张应力,以避免GaN外延层在硅衬底上形成裂纹,Krost的研究表明,AlN缓冲层的厚度与应变减小之间呈现正相关,缓冲层厚度达到12nm时,通过适当的生长方案,可以在硅衬底上生长超过6μm厚的外延层而无外延层开裂现象。
经过研究人员的长期努力,硅衬底上生长的GaN外延层质量已经得到了显著提升,场效应晶体管、肖特基势垒紫外探测器、蓝绿LED和紫外激光器等器件已经取得显著进展。
综上,由于常用的GaN外延衬底均为异质外延,均不同程度面对晶格失配、热膨胀系数差异大等共性问题,同质外延的GaN衬底囿于技术成熟度的限制,衬底尚未实现规模化量产,生产成本高,衬底尺寸小,衬底质量也不够理想,GaN外延新衬底的开发和外延质量提升仍是制约GaN外延产业进一步发展的重要因素之一。
肆 GaN外延常用方法
MOCVD(化学气相沉积法)
看似在GaN衬底上进行同质外延是GaN外延的最优选择,然而由于
化学气相沉积法的前驱体是三甲基镓和氨,载气是氢气,典型的MOCVD法生长温度约1000-1100℃,MOCVD方法生长速度约每小时几微米的级别,且可以生产原子级陡峭的界面,非常适合生长异质结、量子阱、超晶格等结构。其较快的生长速度、良好的均匀性、适于大面积和多片生长的特性常用于工业化生产。
MBE(分子束外延)
分子数外延中Ga采用元素源,活性氮通过RF等离子体由氮气获得,与MOCVD方法相比,MBE生长温度低约350—400℃,较低的生长温度可以规避高温环境下可能带来的某些污染。MBE系统在超高真空度下工作,这允许其集成更多原位检测手段,同时其生长速率和产能无法与MOCVD相提并论,更多用于科研工作方面[7]。
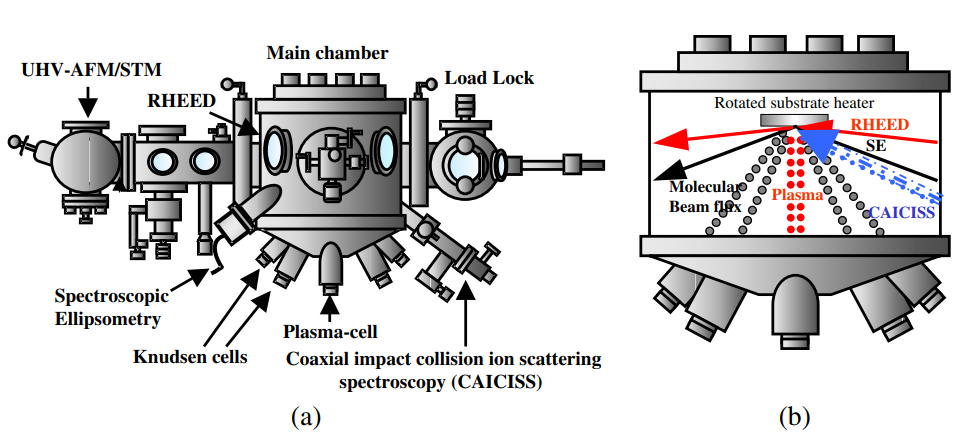
图表 5 (a)Eiko-MBE示意图 (b)MBE主反应室示意图
HVPE法(氢化物气相外延)
氢化物气相外延法的前驱体是GaCl3和NH3,Detchprohm等曾利用此法在蓝宝石衬底表面生长了数百微米厚的GaN外延层,在他们的实验中蓝宝石衬底和外延层间生长了一层ZnO作为缓冲层,并将外延层从衬底表面剥离了下来。与MOCVD和MBE相比,HVPE法的主要特点是生长速率高,适于制作厚层和体材料。不过外延层厚度朝过20μm时,该方法制作的外延层容易产生裂纹。
Akira USUI在该方法基础上引入图形化衬底技术,他们首先通过MOCVD方法在蓝宝石衬底上生长了一薄层1-1.5μm厚的GaN外延层,该外延层由一层20nm厚的低温条件下生长的GaN缓冲层和一层高温条件下生长的GaN层组成。然后在430℃下,在外延层表面镀一层SiO2,并通过光刻工艺在SiO2薄膜上制作窗口条纹,条纹间隔为7μm,掩膜宽度1μm到4μm不等。经过这种改进,他们在2英寸直径的蓝宝石衬底上获得了即使厚度增加到几十甚至数百微米依然无裂纹,像镜子一样光滑的GaN外延层,且缺陷密度由传统HVPE方法的109-1010cm-2降至约6×107cm-2。他们在实验中还指出当生长速度超过75μm/h后,样品表面将变得粗糙[8]。
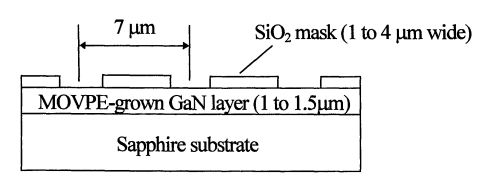
图表 6 图形化衬底示意图
伍 总结与展望
GaN材料因2014年蓝光LED获得当年诺贝尔物理学奖开始崭露头角,以消费电子领域的快充应用走入大众视野,事实上在大部分人看不到的5G基站中使用的功率放大器和射频器件等方向应用也已悄然兴起,近年来GaN基车规级功率器件的破题,有望为GaN材料应用市场打开新的增长点。
庞大的市场需求必将推动GaN相关产业和技术的大发展,随着GaN相关产业链的成熟和完善,当下GaN外延技术面对的问题终将得到改善或克服。未来人们必将开发出更多可供选择的外延新技术和更多更优秀的衬底选项,届时,人们将能够根据不同的应用场景的特点选择该应用场景下最适合的外研技术和衬底,生产出最具竞争力的定制化产品。
参考文献
[1] 「关注」半导体材料-氮化镓 (baidu.com)
[2]唐林江,万成安,张明华,李莹,宽禁带半导体材料SiC和GaN的研究现状,军民两用技术与产品,2020年3月,总第437期,21-28.
[3]王欢,田野,硅衬底氮化镓大失配应力调控方法研究,科技创新与应用,2023年3期
[4]L.Liu, J.H.Edgar, Substrates for gallium nitride epitaxy,Materialss Science and Engineering R, 37(2002) 61-127.
[5]P.Ruterana, Philippe Vermaut, G.Nouet, A.Salvador, H.Morkoc, Surface treatment and layer structure in 2H-GaN growth on the (0001)Si surface of 6H-SiC by MBE, MRS Internet J.Nitride Semicond. Res.2(1997)42.
[6]M.A.Sanchez-Garcia, F.B. Naranjo, J.L.Pau, A.Jimenez, E.Calleja, E.Munoz,Ultraviolet electroluminescence in GaN/AlGaN single-heterojunction light-emitting diodes grown on Si(111),Journal of Applied Physics 87,1569(2000).
[7]Xinqiang Wang, Akihiko Yoshikawa, Molecular beam epitaxy growth of GaN, AlN and InN, Progress in Crystal Growth and Characterization of Materials 48/49 (2004) 42-103.
[8]Akira Usui,Haruo Sunakawa,Akira Sakai and A. atsushi Yamaguchi, Thick GaN epitaxial growth with low dislocation density by hydride vapor phase epitaxy, Jpn. J. Appl. Phys. Vol. 36 (1997) pp.899-902.
原文始发于微信公众号(六方半导体):第三代半导体GaN及相关外延技术简介
一颗芯片的制造工艺非常复杂,需经过几千道工序,加工的每个阶段都面临难点。欢迎加入艾邦半导体产业微信群:

长按识别二维码关注公众号,点击下方菜单栏左侧“微信群”,申请加入群聊

