
2024年10月,成都奕成科技股份有限公司(简称“奕成科技”)实现板级高密FOMCM平台批量量产,成为中国大陆目前唯一具备板级高密FOMCM产品量产能力的公司,标志着奕成科技在FOPLP先进封测领域迈出了坚实有力的一步。

AI发展需求,推动 FOPLP 出圈
随着人工智能技术的不断发展,AI芯片市场已经进入了一个前所未有的黄金时代。无论是在自动驾驶、智能设备,还是以ChatGPT、百度文心一言等为代表的大语言学习模型,AI芯片的需求激增,推动了整个半导体行业的技术创新。然而,面对海量数据处理和复杂计算的需求,传统芯片封装技术已显得捉襟见肘,先进制程SoC系统集成方案成本高昂且逼近物理极限,以CoWoS为代表的先进封装产能告急。如何提升芯片性能、缩短上市周期同时控制成本,成为AI厂商们亟需解决的问题。
在这场技术竞赛中, FOPLP(板级扇出型封装)迅速崭露头角,这项先进封装技术通过将半导体芯片重新分布在大面板上,进行扇出布线,从而提供了更高的灵活性、可扩展性和成本效益,同时高I/O密度和优异的电气性能等特性在高端应用中优势明显,因而成为AI厂商的新晋“宠儿”。至此,各大不同商业模式的厂商纷纷抢滩FOPLP,进一步证明了市场对FOPLP技术的广泛认可和高度期待。
FOPLP技术的优势
高产出率:FOPLP使用方形基板进行IC封装,相较于圆形12寸晶圆级封装,其使用面积增加,产出效率可提升4-6倍之多,提高了生产效率。
大尺寸系统集成:晶圆级受限于300mm基板和圆形物理形态,对应大尺寸产品(如高性能计算、人工智能等领域的GPU、FPGA)时,边缘浪费大,产出效率低并且需多次曝光拼接,而板级封装可以更好地对应大尺寸集成。
成本效益:方形基板能摆放更多的芯片,生产效率提升,涂布、切割等工艺过程中浪费的材料减少,同时单次曝光面积大,应对大尺寸系统集成时无需拼接,总体成本相对降低。
技术优势:具备容纳更多I/O数、体积更小、效能更强、节省电力消耗等特点。
聚焦高端应用,奕成科技板级FOMCM批量量产
在快速的技术革新与激烈的竞争背景下,本次奕成科技量产的板级高密FOMCM产品实现了多芯片集成的高密度封装,采用多层高密度重布线层(RDL)互连技术,成功将多颗Chiplets小芯片进行系统集成封装。产品主要应用于人工智能领域,同样适用于智能计算、自动驾驶、数据中心等多个前沿领域。奕成科技团队先后攻克了再分布层RDL线宽线距、大板翘曲、芯片对位焊接、大板电镀、研磨均匀性等业界公认的技术难点,满足了AI芯片对于高带宽、低延迟、低功耗等性能的严格要求,特别是在大算力需求的人工智能应用场景下,该产品提供了优异的解决方案,实现了创新性的技术突破。
奕成科技董事长李超良表示:“后摩尔时代,伴随着全球终端市场的多样化发展需求,板级高密封装成为提升芯片性能的领先解决方案。本次板级FOMCM技术平台的批量量产,是公司技术发展的又一里程碑。奕成科技将不负使命,通过与产业链伙伴协同合作,持续推动板级封测技术的创新发展,为全球客户提供卓越的一站式板级系统封测服务。”

奕成科技董事长李超良发表讲话
奕成科技FOMCM技术平台优势
01 高密度大尺寸集成
通过将多个小芯片 (Chiplets) 集成在一起,实现高密度的系统集成。
02 卓越性能
传输频带宽、通信容量大、传输损耗低、散热能力强。
03 广泛应用
可广泛应用于高性能计算、人工智能等高端领域,为多场景(计算、存储、感知、执行等)系统封装提供解决方案。
04 可控成本
奕成板级FOMCM使用510*515mm方形基板进行IC封装,相较于300mm的圆形晶圆,具有更高的材料、设备利用率和单板产出效率(4-6倍),因而拥有更优异的成本竞争力。
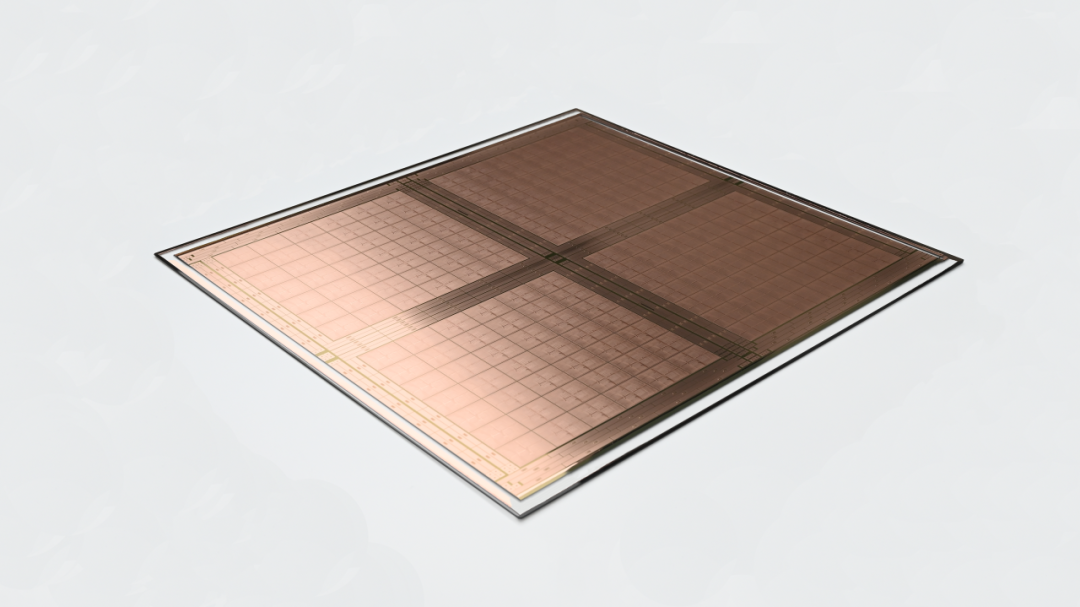
奕成科技板级高密FOMCM封装产品
深耕板级高密封装,助力AI芯发展
奕成科技专注板级高密集成封装,技术平台可对应2D FO 、2.xD FO、FOPoP 、FCPLP等先进系统集成封装,可针对客户的灵活化需求,提供领先的板级系统封装解决方案。
公司自2017年便布局板级高密封装赛道,切入市场先机,拥有深厚的技术储备和丰富的量产经验,可实现2um线宽线距高密布线、高精度芯片与芯片(Die to Die)对位等领先工艺,通过持续提升芯片功能密度、缩短互联长度、增加系统重构灵活度,不断优化大板封装的产出效能和产品品质。
坐落于四川成都的奕成科技板级高密封装工厂总投资55亿人民币,于2023年4月实现投产,12月完成首批产品量产交付, 本次板级高密FOMCM平台批量量产后,公司将加速产能爬坡,持续满足高端应用的发展需求,为FOPLP产业的蓬勃发展和AI未来注入中国力量。
原文始发于微信公众号(ECHINT 奕成科技):助力AI芯发展 | 奕成科技板级高密FOMCM批量量产


