本文根据湖南越摩先进马晓波副总监在2025年玻璃基板TGV产业链高峰论坛上的演讲整理,仅供传递行业信息。
在本次论坛上马晓波副总监主要从AI浪潮下的先进封装机遇、玻璃基板的技术优势与挑战、多物理场仿真与AI驱动、未来展望几方面给大家详述了多物理场仿真技术在玻璃基先进封装中的应用。

一、AI浪潮下的先进封装机遇
当ChatGPT掀起全球AI狂潮,算力需求正以指数级增长。据预测,2025年全球AI市场规模将突破2,212亿美元,而中国将成为1,671亿美元的主战场。

在这场算力竞赛中,传统封装技术已难以为继:
✅ 芯片尺寸越来越大:GPU封装从50×50迈向110×110,有机基板翘曲失控
✅ 互联密度要求更高:Chiplet技术推动线距从40μm缩至25μm
✅ 可靠性挑战升级:自动驾驶、航天军工场景需耐受-55℃~125℃极端温变

行业共识:先进封装成AI芯片性能跃迁的关键!而玻璃基板,正在成为破局的核心技术。
二、玻璃基板的技术优势与挑战
1.核心优势
低翘曲(Warpage):70×70尺寸GPU的翘曲控制在100μm以内(有机基板极限为300μm)。
高密度互联:支持更薄基板(如800μm厚度),提升电性能(信号完整性/电源完整性)。
散热与可靠性:玻璃的机械性能优异,温循测试性能提升25%-40%,适用于军工、航天等高要求场景。
2.应用案例
大尺寸GPU封装:70×70四芯片方案,芯片面积利用率提升至54%(有机基板为32.6%),封装面积减少40%。

玻璃中介层(Interposer):与硅基方案竞争,计划推出样品,目标线距≤2μm、孔径≤10μm。
3.挑战与突破
成本:当前玻璃基板成本为有机基板的4-10倍,目标1-1.3倍以内(需产业链协同降本)。
良率:压合工艺和TGV(Through Glass Via)良率待提升,需优化材料(如国产ABF)与制程。
标准缺失:推动与客户联合制定Chiplet互联标准,加速技术落地。

三、技术创新:多物理场仿真与AI驱动

1.自动化仿真平台
实现无工程师干预的快速仿真,效率提升4-5倍,误差≤4%。
支持应力、散热、流体等多物理场分析,应用于GPU翘曲优化与可靠性验证。

2.深度学习赋能
采用双层神经网络训练模型,仿真效率提升百倍(1-5分钟完成传统需数小时的任务)。
动态仿真与参数优化,减少对传统建模的依赖,加速设计迭代。
四、湖南越摩先进的战略布局
1.产线与客户
华中最大先进封装基地,覆盖SiP、FCBGA、Chiplet等产线,服务AI、自动驾驶、物联网客户。

湖南越摩公司SiP先进封装生产线
计划推出玻璃基板GPU样品,规划2025年量产110×110大尺寸产品。
2.产业链协同
控股股东资源:上海兴橙资本投资晶圆厂(广州12寸厂)、EDA/IP公司(如概伦电子/芯原),布局硅基/玻璃基2.5D封装。
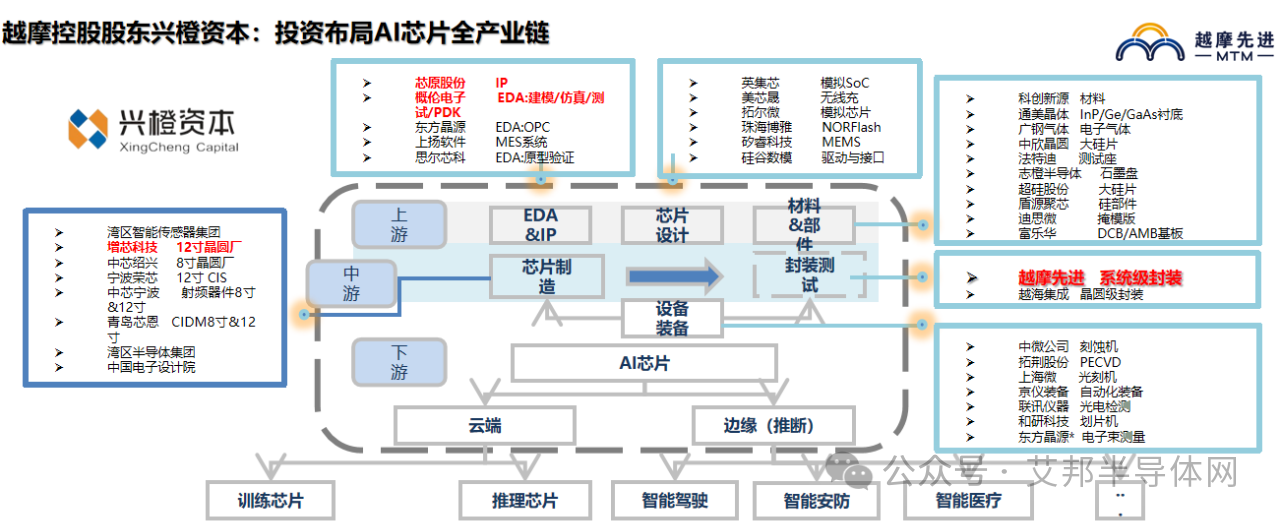
产业联盟:联合AI、自动驾驶客户形成生态,推动技术验证与商业化。
五、未来展望
技术路径:聚焦玻璃基板与3D Hybrid Bonding结合,解决大尺寸封装最后一公里问题。
市场拓展:从AI服务器向消费电子(AIPC/手机)、自动驾驶渗透,平衡性能与成本。
行业呼吁:需全产业链协作(材料、设备、封装厂)降低玻璃基板成本,加速替代有机基板。
总结:湖南越摩先进通过玻璃基板技术创新与AI驱动的仿真能力,瞄准AI芯片封装痛点,致力于成为先进封装领域的关键参与者,推动国产半导体生态升级。
-end-
艾邦建有玻璃基板与TGV技术交流群,可以加强产业链的合作,促成各企业的需求对接,同时您也可以与行业精英共同探讨玻璃基板及TGV技术的前沿动态,共享资源,交流经验,欢迎您的加入。

活动推荐一:第二届玻璃基板TGV产业链高峰论坛(8月26-27日 深圳)




