三维集成是后摩尔时代集成电路发展的主要技术途径。玻璃通孔(TGV)技术与传统的三维封装技术相比,有着成本低、高频损耗小、集成度高、热膨胀系数可调等显著优势,已成为国内外研究的热点,被英特尔誉为“新的游戏规则改变者”。电子科技大学张继华教授团队在国内率先开启三维集成玻璃通孔材料和集成技术研究,联合成都迈科科技有限公司在新型可光刻玻璃基板、超细玻璃通孔及超高深径比通孔填充等方面取得了一系列新进展。
一、可光刻玻璃材料介电损耗控制方法
针对光敏玻璃介电损耗与可光刻性难以兼顾的技术难点,团队发明了低损耗的可光刻玻璃基板及生产方法,利用中和碱效应、压制效应和稳定效应,减小光敏玻璃介电损耗,在低损耗玻璃材料设计、热匹配设计与制备工艺等方面取得了一系列关键技术突破[1-6,17],开发出兼具良好介电性能和刻蚀选择性的可光刻玻璃,其光敏性与介电损耗如图1所示。研制的光敏玻璃介电损耗为1‰~2‰@500 MHz,感光波长范围为310~320 nm,与国际上唯一一款商用光敏玻璃肖特Foturan II相比介电损耗降低一半以上,并实现了小批量生产。

(a)团队研制的样品与肖特Foturan II玻璃光敏性对比

(b)不同光敏剂含量对介电损耗的影响
图1 可光刻玻璃的光敏性与介电损耗[3]
二、高质量超细孔径玻璃通孔形成技术
团队在总结TGV技术特征发展的基础上,提出了TGV的划代标准及第三代TGV技术(TGV3.0)——利用激光成丝诱导局域多光子吸收原理结合湿法腐蚀方法,摆脱了第二代TGV技术(光敏玻璃)对单一玻璃材料的限制。研究了可光刻玻璃中光、热、化学对玻璃的作用机理,掌握了基于可光刻玻璃的高密度通孔形成技术,研制出最小孔径为5 μm、最大深径比可达80∶1、最大通孔密度为250 000 cm-2的超细孔径玻璃通孔基板。提出了一种考虑到侧壁粗糙度的精确RLGC电气模型,掌握了孔内壁粗糙度对微波性能的影响规律,通过控制激光诱导湿法蚀刻工艺,使侧壁粗糙度从1.257 µm降低到25 nm,从而提高了玻璃三维集成电路中信号传输的完整性和可靠性[10-12],优化结果如图2所示,TGV孔内壁粗糙度对信号完整性的影响如图3所示。

(a)~(f)6个工艺参数下的样品3D显微镜图
(g)6组样品均方根粗糙度测试结果
图2 TGV侧壁粗糙度优化工艺及结果[10]

(a)孔壁模型
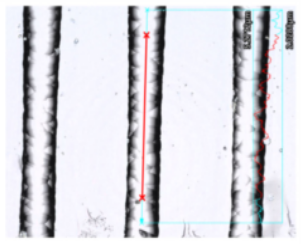
(b)侧壁粗糙度3D显微镜照片
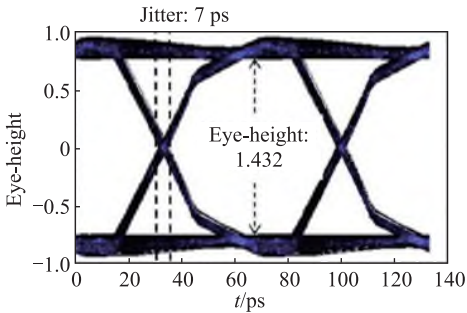
(c)0.025 μm 侧壁粗糙度对应的眼图
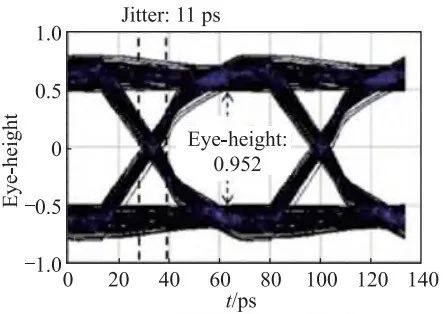
(d) 0.8 μm 侧壁粗糙度对应的眼图
图3 TGV孔内壁粗糙度对信号完整性的影响[10]
该模型获得了IEEE TMTT审稿人的高度认可:“这项工作以一种全面、适当且技术上健全的方式涵盖了现代射频/微波应用中的三维芯片封装和集成的相关主题。通过分析模型、全三维有限元模拟、等效集总元件网络以及从物理样本中收集的实验数据,探讨了TGV表面粗糙度对三维堆叠集成电路微波性能的影响,并进行了相应的优化。”
三、超高深径比玻璃通孔金属化技术及应用
传统通孔种子层必须采用设备昂贵的深孔溅射PVD设备,且深径比不超过10∶1。团队提出一种玻璃深孔内壁镍磷金属种子层制备的化学镀方法,摆脱了对成本高、深径比小的深孔溅射PVD设备的依赖,实现了最大50∶1的超高深径比玻璃通孔孔壁种子层制备,大幅减小种子层制作成本。优化了超高深径比玻璃通孔电镀液配方和工艺,发明了通孔侧壁附着、晶圆级深孔电镀、玻璃/厚铜复合层精密抛光以及中间向两端生长的通孔金属填充方法。攻克了三维集成TGV集成度低的堡垒,兼顾了集成度和微波性能。通孔金属化及其不同形貌、间距对传输特性的影响规律如图4所示。

(a)GSG型双曲线TGV测试结构
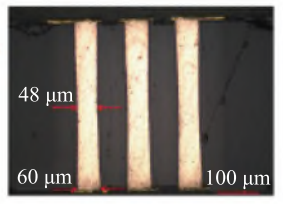
(b)直径为60 μm的金属化TGV的横截面(p=4ra)
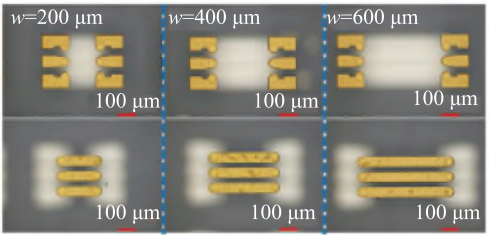
(c)不同节距的测试结构的俯视图/仰视图
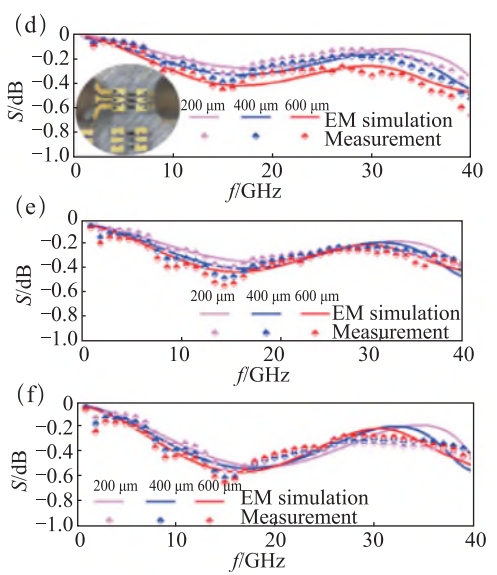
(d)~(f)p=4ra,p=6ra和p=8ra时TGV测试结构插损电磁模拟和测量结果
图4 通孔金属化及其不同形貌、间距对传输特性的影响规律
此外,团队提出一种用于提取双曲线TGV寄生特性的通用分析方法,以便更有效地评估微波器件的电气性能[7]。面对具有低基板损耗的玻璃通孔存在信号失真的问题,团队提出了一个宽带可扩展模型,用于评估信号可靠性和合理化玻璃穿孔器中的三维集成设计[8]。基于先前研究,实验室利用TGV技术,开发了使用集成的左右手双复合(ID-CRLH)谐振器单元实现小型化带通滤波器的合成方法[9]。此外,团队在高Q芯片电感、新型滤波器、封装天线等应用领域[13-16,18-20]也取得了重要进展,为我国高性能微波器件提供了新的解决方案。
未来,团队研究内容将向一“大”一“小”发展,“大”就是将TGV基板由晶圆级扩展到面板级,“小”则是进一步将亚10 μm缩小到亚μm,突破通孔孔径极限,扩展更多应用场景,持续领跑TGV技术。基于TGV的三维结构化玻璃材料还可以扩展应用到微流控芯片、MicroLED基板、折叠显示屏、电子雾化芯等。(吉力小兵,张继华)
原始文献:
[1] LIANG T P, ZHANG J H, CHEN H W, et al. Enhanced dielectric properties of Ca2+ doped Li-Al-Si photoet chable glass[J]. Ceramics International, 2018, 44(8): 8756-8760.
[2] LIANG T P, ZHANG J H, CHEN H W, et al. Effect of Al2O3 on structural dynamics and dielectric properties of lithium metasilicate photoetchable glasses as an interposer technology for microwave integrated circuits[J]. Ceramics International, 2020, 46 (11): 18032-18036.
[3] LIANG T P,ZHANG J H, CHEN H W,et al. Effect of B-doping, UV exposure and thermal annealing on dielectric properties and crystallization behavior of Li-Al-Si photoetchable glasses[J]. Ceramics International, 2020, 46 (18): 28108-28113.
[4] LIANG T P,ZHANG J H, CHEN H W, et al. Influence of exposure energy and heat treatment conditions on through-glass via metallization of photoetchable glass interposers[J]. Ceramics International, 2021, 47 (1): 1277-1283.
[5] LIANG T P, ZHANG J H, CHEN H W, et al. Impact of alkaline earth metal doping on dielectric properties of Li-Al-Si photoetchable glasses as interposers for integrated circuits packaging[J]. Journal of Alloys and Compounds, 2021, 874: 159546.
[6] LIANG T P, ZHANG J H, CHEN H W, et al. Dielectric and thermodynamic properties of Ba-doped photoetchable glasses for three dimensional RF microsystem packaging[J]. Ceramics International, 2021, 47 (10): 14226-14232.
[7] LI W L, ZHANG J H, WANG L Y, et al. General analytical method for investigating parasitic characteristics of through glass vias (TGVs) in 3-D integration[J]. IEEE Transactions on Electron Devices, 2023, 70 (9): 4554-4559.
[8] LI W L, ZHANG J H, GAOL B, et al. Wideband analysis and prolongation of surrounding TGVs shieldingstructure in 3-D ICs[J]. IEEE Microwave and Wireless Technology Letters, 2023, 33 (1): 39-42.
[9] LI W L, ZHANG J H, GAO L B, et al. Compact TGV-based bandpass filter susing integrated dual composite right/left-handed resonators[J]. IEEE Transactions on Circuits and Systems II: Express Briefs, 2023, PP (99): 1.
[10] FANG Z, ZHANG J H, LIU J X, et al. Analysis and optimization of sidewall roughness on microwave performance of through-glass vias in 3-D integrated circuits[J].IEEE Transactions on Microwave Theory and Techniques, 2024, 72 (1): 54-63.
[11] FANG Z, ZHANG J H, GAO L B, et al. Derivation and analysis of a hemispherical physicalmodel and the correction factors for the sidewall roughness of through-glass vias[J]. IEEE Transactions on Microwave Theory and Techniques, 2023, PP (99):1-12.
[12] FANG Z, ZHANG J H, GAO L B, et al. Closed-form expressions of parasitic parameters for different sidewall roughness of through-silicon via sinter connects[J]. IEEE Transactions on Electron Devices, 2024, 71 (2): 1160-1165.
[13] FANG Z, ZHANG J H, GUOY H, et al. Enhancing glass-to-glass bonding at room temperature susing laser surface modification with Ti/Cu/Ti/TiO2 thin films[J]. IEEE Transactions on Components, Packaging and Manufacturing Technology, 2023, 13 (9): 1502-1509.
[14] FANG Z, ZHANG J H, GAOL B, et al. Absorptive filtering packaging antenna design based on through-glass vias[J].IEEE Transactions on Components, Packaging and Manufacturing Technology, 2023, 13 (11): 1817-1824.
[15] FANG Z, GAO L B, CHEN H W, et al. 3D interdigital electrodesdielectric capacitor array for energy storage based on through glassvias[J]. Advanced Materials Technologies, 2022, 7 (8): 2101530.
[16] FANG Z, ZHANG J H, GAO L B, et al. Ka-band broad band filtering packaging antenna based on through-glass vias (TGVs)[J]. Frontiers of Information Technology & Electronic Engineering, 2023, 24 (6): 916-926.
[17] ZHAO H L, ZHANG J H, CHEN H W, et al. The effects of La2O3 doping on the photo sensitivity, crystallization behavior and dielectric properties of Li2O-Al2O3-SiO2 photo structurable glass[J]. Ceramics International, 2018, 44 (17): 20821-20826.
[18] ZHOU G Y, GAO L B, CHEN Y Z, et al. High induct ancedensity glass embedded inductors for 3-D integration[J]. IEEE Microwave and Wireless Technology Letters, 2023, 33 (6): 679-682.
[19] WANG L Y, CHEN H W, LI W L, et al. A 28-GHz compact substrate integrated waveguide bandpass filter with defected ground structure using TGV technology[J]. IEEE Transactions on Components, Packaging and Manufacturing Technology, 2023, 13 (12): 2008-2015.
[20] GAO L B, LIU M H, QU S,et al. Nano-scanning calorimetry applied to phase change processes in GeTe thin films[J]. IEEE Transactions on Electron Devices, 2023, 70 (8): 4128-4132.
张继华教授团队(微波介质与集成器件团队)是电子薄膜与集成器件全国重点实验室的核心团队,依托电子科技大学和成都迈科科技有限公司,主要面向后摩尔时代集成电路发展对关键材料和集成技术的需求,探索异质异构材料和集成方法。团队现有教师8人,包括教授/正高级工程师3人,副教授/高级工程师4人,博士后1人;研究生30余人,其中博士生7人。近5年承担国家级重点科研项目10余项。荣获“全国创新争先奖牌”等国家、省部级奖励4项,获授权发明专利50余项,制定国家标准1项。近年来从事超摩尔的三维集成关键材料与集成技术研究与产业化工作,在行业内提出TGV3.0(第三代玻璃通孔技术),率先突破亚10 μm通孔和填充技术,其被鉴定为整体国际先进技术,其中通孔尺寸、孔密度和深径比国际领先,产生直接经济效益6.21亿元,是国际上率先开展后摩尔时代玻璃通孔三维集成技术的团队之一。
1. 率先提出TGV3.0,突破低损耗、高深径比玻璃通孔三维集成技术
针对后摩尔时代集成电路向三维集成的发展趋势,开发了高性能射频微系统三维集成转接板——可光刻玻璃及其TGV技术,获2017年度全国创新争先奖表彰。
2. 突破薄膜集成器件(IPD)产业化关键技术,协助风华高科等企业产业升级
针对无源元件的薄膜集成,发明了薄膜电路基片、复合电极制备与图形化等方法,解决了薄膜器件产业化中的一致性、可靠性问题,在广州翔宇和风华高科分别建立起2条生产线。使薄膜电路、温度传感器、低成本薄膜电路基片等在国内率先实现工业化规模生产,新增产值2.5亿元,打破了美日等在薄膜集成器件领域的垄断,使我国企业成长为高端薄膜集成器件生产商,获2017四川省技术发明奖、2022广东省电子信息科学技术奖。
3. 探索介电/半导体异质集成耦合机理,为基于介电/半导体集成的新型电子器件的研制奠定了理论基础
针对有源/无源集成中异质材料相互作用机理问题,建立起铁电/GaN调制耦合模型,预测了极化调制、应变耦合和介电增强等新效应;国际上率先提出基于铁电极化的新型功率器件和GaN增强型器件,为基于介电/半导体集成的新型电子器件的研制奠定了理论基础,在国际国内学术会议作大会邀请报告5次。
来源:电子与封装
吉力小兵, 张继华. 玻璃基三维集成技术领域系列研究新进展[J]. 电子与封装, 2024, 24(3): 030601 .
https://ep.org.cn/CN/Y2024/V24/I3/30601


