随着5G时代高带宽的计算、传输、存储的要求,以及硅光技术的成熟,板上和板间也进入了光互连时代,通道数也大幅增加,由专用集成电路(ASIC)控制多个光收发模块。在封装上要将光芯片或光模块与ASIC控制芯片封装在一起,以提高互连密度,从而提出了光电共封装的相关概念。
光电共封装较传统的板边以及板中光模块在带宽、尺寸、重量和功耗有重要的优势,传统光互连采用板边光模块和板中光模块。光电共封装是将光收发模块与ASIC芯片封装在一个封装体内,包括2.5D封装和3D封装,能实现更高的互连密度和更低功耗,且损耗更小。然而光电共封装也面临一系列难点,包括高密度光电载板工艺、高精度的光电芯片组装工艺、阵列光纤连接器的装置耐高温性等。
今天,我们将介绍国际上一种基于玻璃基板的光电共封装方案。
基于玻璃载板的光电共封装方案
玻璃材料由于其对光透明,对电绝缘性好的性能,很适合作为光电载板。佐治亚理工提出了一种基于玻璃载板的光电混合封装方案,如图1所示。
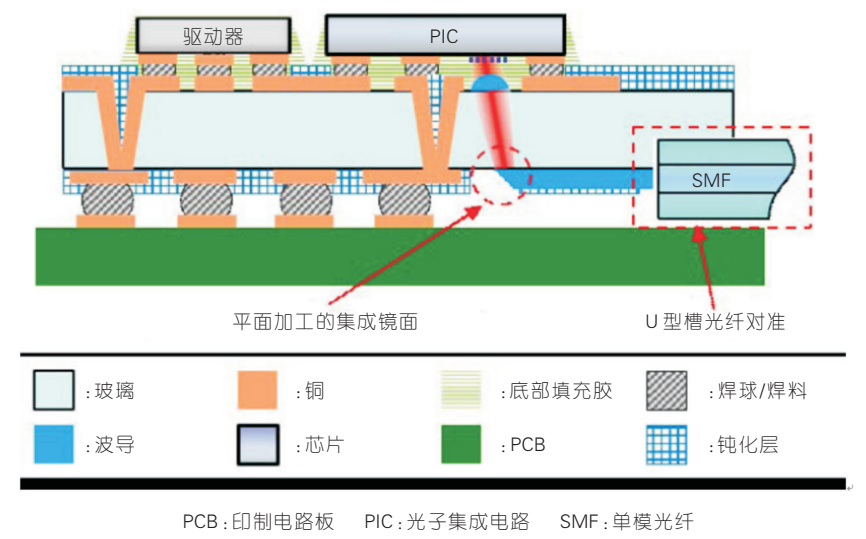
图1 3D玻璃基板封装示意图
该方案采用150um厚的玻璃载板,PIC和驱动芯片和跨阻放大器倒装在玻璃载板上,光通过载板上的有机透镜聚焦到载板背面的波导中,与光纤耦合;电信号通过在玻璃基板上做金属通孔(TGV)引出。
选用玻璃作为载板,优势在于电学损耗要小于硅;但缺点在于玻璃的加工比较困难,与常规微电子硅工艺不完全兼容,尤其对玻璃基板的打孔、电镀、清洗工艺等。目前还没有较稳定成熟的工艺,另外玻璃的散热能力较差,所以需要考虑合适的散热方案。
基于玻璃转接板的三维光电共封装设计和制备
玻璃转接板具有透明、绝缘等良好的光学电学性能,玻璃转接板2.5D光电共封装方案如图2a)所示。但玻璃转接板加工工艺比较困难,本研究对石英玻璃转接板的打孔、电镀、图形刻蚀做了多方面的研究,制作了玻璃转接板。同时,研究对TGV的电学性能进行了仿真,图2b)是TGV的插入损耗曲线,图2c)是TSV与TGV的插入损耗曲线对比。
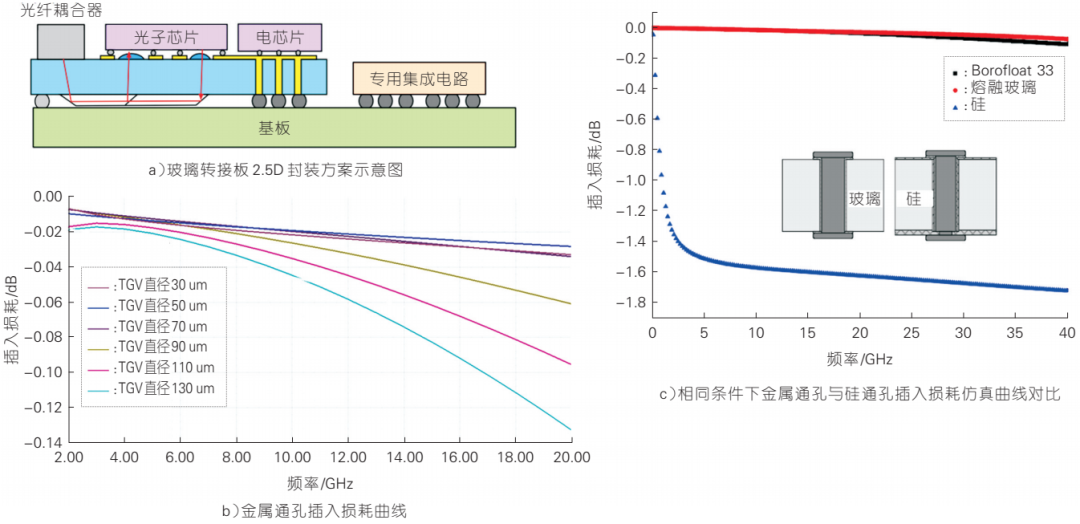
图2 采用玻璃转接板的设计仿真结果
比较相同条件下TGV和TSV的损耗曲线(S21曲线),可以看出TGV的高频性能远好于TSV,并且金属直径越小,高频性能越好,当TGV直径小于70um时,插入损耗差别不大。因此考虑到制作的可行性,本研究针对70um直径TGV晶圆进行了研发制作。
在15.24cm(6英寸)的300um厚玻璃基板上,采用激光钻孔方式制作了70um直径的通孔,晶圆表面溅射一层100nm/1μm的Ti/Cu金属薄膜作为种子层,然后进行填实电镀铜,观测了电镀好TGV的X射线照片,可见TGV通孔电镀质量良好,之后对玻璃基板进行表面图形化蚀刻,最后在玻璃转接板表面做了镍钯金处理,将电芯片倒装键合在转接板上,完成玻璃转接板微组装。
总结
随着近年来硅光技术的不断发展成熟,硅光芯片的光电共封装采用陶瓷基板、有机基板、玻璃载板、硅基板将电芯片与硅光芯片集成,封装集成也从2.5D向着3D光电共封装发展。
因为玻璃芯通孔之间的间隔能够小于 100 微米,这直接能让晶片之间的互连密度提升10倍。而且,玻璃基板在热学性能、物理稳定度方面表现都更出色、更耐热,不容易因为温度高而产生翘曲或变形的问题。所以,玻璃基板在2.5D/3D光电共封装中也有很大优势。
例如康宁玻璃晶圆/面板主要服务于包括先进封装和光电共封装(CPO)客户,以玻璃载板平整度以及热膨胀系数(CTE)于客户的晶圆相互匹配,康宁熔融下拉工艺可以提供非常完美的表面质量、平整度,以及大尺寸和可量产性。除了玻璃基板,还将它做成玻璃晶圆/面板成品给到客户,包括先进封装和光电共封装(CPO)客户。
来源:高速高密度光电共封装技术
DOI: 10.3969/j.issn.1009-6868.2018.04.005

艾邦建有玻璃基板与TGV技术交流群,可以加强产业链的合作,促成各企业的需求对接,同时您也可以与行业精英共同探讨玻璃基板及TGV技术的前沿动态,共享资源,交流经验,欢迎您的加入。

活动推荐:
|
Topic |
Companies to be invited |
|
Challenges and solutions of TGV glass core technology |
Guangdong Fozhixin Microelectronics Technology Research Co., LTD |
|
Difficulties in the production of TGV metal lines and their technical solutions |
Hubei TGVTECH Co., Ltd. |
|
Glass core substrate: a new generation of advanced packaging technology |
AKM Meadville Electronics (Xiamen) Co. Ltd. |
|
The latest generation of TGV technology and applications |
3D CHIPS (GUANGDONG) TECHNOLOGYCO.,LTD |
|
SCHOTT glass enables advanced packaging |
SCHOTT Group |
|
Application of microscope in semiconductor advanced packaging defect detection |
Guangdong Huipuguangxue Technology Co., Ltd. |
|
Prospects for the application of through-glass technology in advanced packaging |
Xiamen Sky Semiconductor Technology Co.Ltd. |
|
Discussion on the filling technology of through-hole in glass substrate |
Guangdong Tiancheng Technology Co., Ltd. |
|
Laser-induced deep etching technology is used to realize the processing of glass substrates with integrated multi-functional structures |
乐普科 中国区 |
|
Design, development and application of high-performance IPD based on TGV |
ShangHai Xpeedic Co., Ltd. |
|
Application of Multi-physics Simulation Technology in Glass-based Advanced Packaging |
Hunan More Than Moore Advanced Semiconductor Co.,Ltd. |
|
High-density glass-level packaging and heterogeneous integration process development challenges and solutions |
Chengdu ECHINT Technology Co., Ltd. |
|
Application of PVD equipment in deep hole coating in TGV technology |
Guangdong Huicheng Vacuum Technology Co., Ltd. |
|
From round to square: Evatec's advanced packaging substrate FOPLP etching and sputtering solutions |
Evatec China |
|
The latest progress and future prospects of glass substrate packaging technology |
Shenzhen Fanxin Integrated Semiconductor Co., Ltd. |
|
Innovative technologies and applications of glass substrates: from plasma vias to surface modification and metal seed layer technology |
UVAT Technology co.,Ltd. |
|
Panel level laser induced etching & AOI |
Shenzhen GH LASER Co., Ltd. |
|
Integrated passive on glass substrate |
SUzhou senwan Electronic Technology Co., Ltd. |
|
玻璃基板量产线 铜线路蚀刻工艺 |
广州市巨龙印制板设备有限公司 |
|
用于TGV封装领域的光学量检测技术 |
北京电子量检测股份有限公司 |
李小姐:18823755657(同微信)
邮箱:lirongrong@aibang.com


https://www.aibang360.com/m/100235?ref=100042
原文始发于微信公众号(艾邦半导体网):基于玻璃基板的光电共封装方案



