SiC芯片可以高温工作,与之对应的连接材料和封装材料都需要相应的变更。三菱电机高压SiC模块支持175℃工作结温,其封装技术相对传统IGBT模块封装技术做了很大改进,本文带你详细了解内部的封装技术。
正文字数:1546;阅读时间:5分钟
为了实现低碳社会,能够高效电能变换的电力电子技术正在扩展到消费、工业、电气化铁路、汽车、太阳能发电和风力发电等各个领域。其中,功率模块在控制电流方面发挥着重要作用,需要减少运行过程中的损耗,减小封装尺寸,并提高功率密度。近年来备受关注的SiC(碳化硅)与以往的Si(硅)相比具有高速开关且低损耗的特点,能够飞跃性地提高性能,因此被期待为下一代的功率器件。此外,由于SiC能够高温工作,因此可以通过减小封装尺寸来促进功率单元的小型化,但为此,需要开发能够应对高温工作的封装材料和结构。
在封装开发过程中,我们提高了键合材料和灌封材料等各部件的耐热性,并开发了对应的工艺技术,特别是提高了对温度循环寿命有影响的键合部位的可靠性,实现了高质量和高可靠性。通过应用这些技术,我们开发了一种支持芯片工作温度(Tjop)175℃高温运行的封装。
图1显示了开发的高温工作全SiC功率模块(FMF185/375/750DC-66A)的封装外观,图2显示了主要结构(示意图)。作为支持175℃高温运行的封装结构,在底板上使用耐高温焊锡来连接耐高温绝缘基板,在绝缘基板上使用Ag烧结技术键合芯片。芯片上面的电极和绝缘基板金属层用Al线连接,与外部电气连接的电极与绝缘基板金属层进行US键合。外壳安装在底板上,内部填充了耐高温灌封材料。

图1:适用于高温工作的封装外观
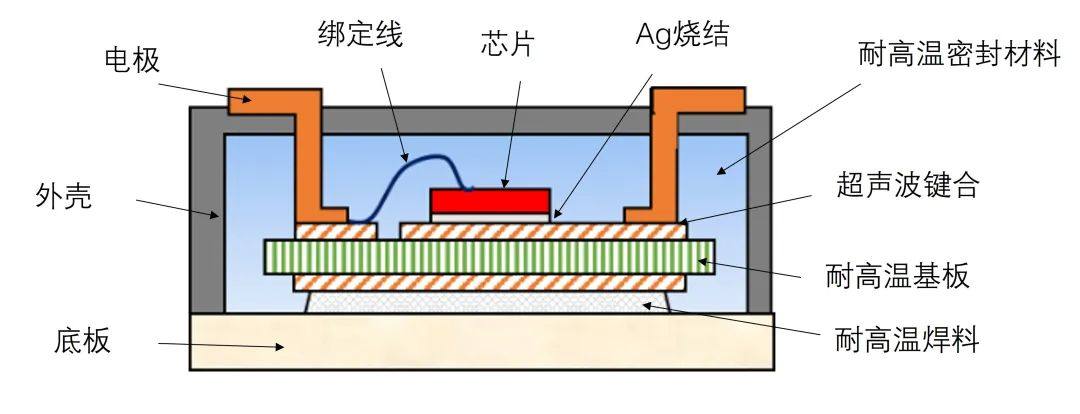
图2:高温运行封装截面图
当考虑芯片的高温运行时,由于传统焊料在芯片键合时的物理限制,因此需要新的键合材料和合适的工艺。本公司开发了使用Ag粒子烧结键合工艺,实现了耐高温、高品质化。
Ag烧结连接工艺进行多个芯片的批量键合。因此,在高温工作封装中,相对于以往封装,芯片尺寸缩小,研究了在4×3的芯片排列中高密度化统一键合。图3显示了通过Ag烧结进行批量键合后的SAT(Scanning Acoustic Tomography)图像,图4显示了键合截面图像。从SAT图像和截面图像的结果来看,键合处没有空隙或龟裂等,可以确认键合状态良好。因此,在高温工作封装中,通过Ag烧结实现了芯片的高密度化和高质量的键合。
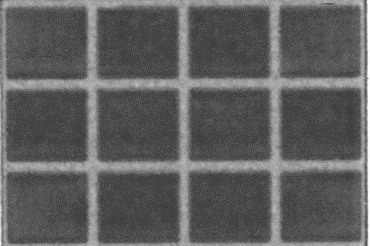
图3:Ag烧结批量键合后的SAT图像

图4:Ag烧结后的横截面图像
过去一直使用AlN(氮化铝)陶瓷的绝缘基板,此次研究了采用Si3N4(氮化硅)陶瓷的耐高温绝缘基板作为新材料。为了评价耐高温性能,对AlN绝缘基板和Si3N4绝缘基板实施温度循环试验,使温度变化为-40~175℃(ΔT=215K),对陶瓷部分和基板金属层的键合部裂纹变化进行检测、确认。结果,如图5所示,AlN绝缘基板的陶瓷部分出现龟裂,而Si3N4绝缘基板在600个循环后也未发生龟裂,实现了耐高温、高可靠性。

图5(a):温度循环测试后的绝缘基板截面图-AlN基板
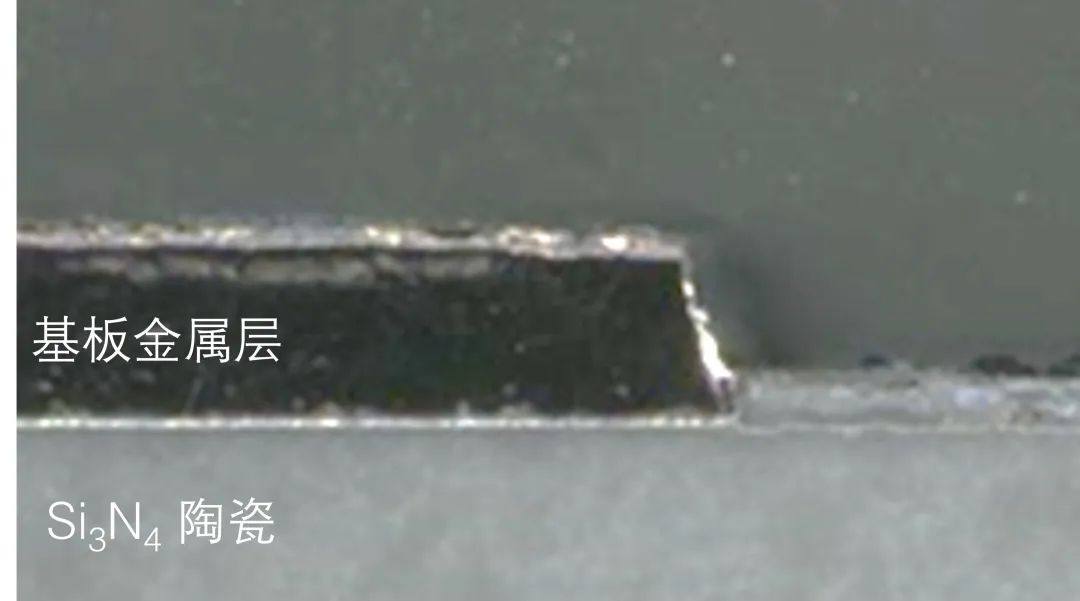
图5(b):温度循环测试后的绝缘基板截面图-Si3N4基板
连接绝缘基板和底板的焊料必须保持键合处无裂纹,以保证对基板的散热,防止芯片过热。因此,我们研究选择了耐久性、耐热性的RoHS焊锡材料。对于耐高温焊料,在表1所示的混合元素基础上添加了多种元素,以提高键合寿命,使其符合绝缘基板和底板的机械物理性能。使用选定的焊料,将Si3N4绝缘基板和底板连接起来,并进行了温度循环试验,其中温度变化为-40~175℃(ΔT=215K)。结果,即使在600次循环后,也没有观察到键合处出现裂纹,并验证了它可以作为耐高温焊料使用(图6)。

表1:耐高温焊锡材料的主要混合元素和效果
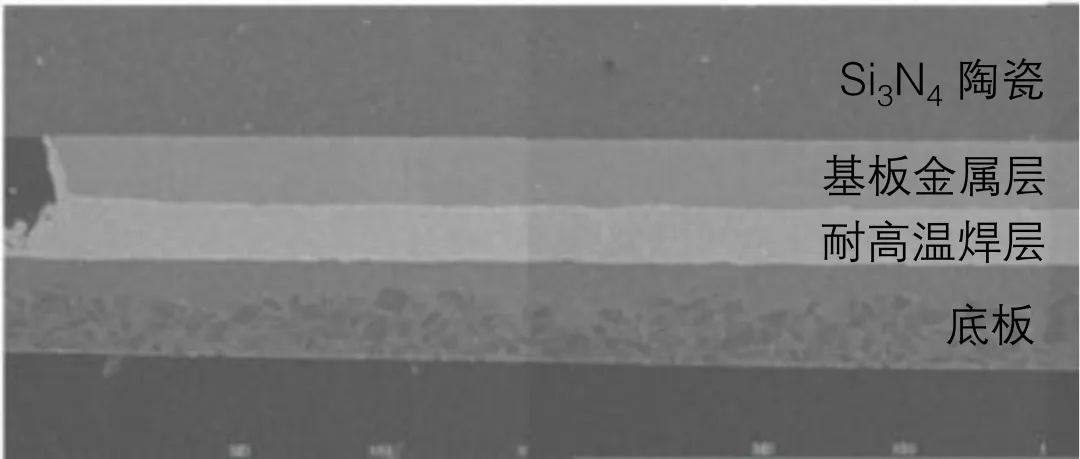
图6:温度循环测试后的焊接层截面图
传统用于电气连接到外部的电极是使用焊料键合到绝缘基板金属层。然而,随着功率密度的增加,由于电极电阻成分引起的发热和电极与基板金属的键合部分温度上升成为问题,因此需要提高高温循环下的键合寿命。因此,我们利用US(超声波)焊接技术将电极与基板金属直接键合在一起,并通过去除焊料提高了键合强度,从而在高温循环中提高了电极与绝缘基板的键合寿命。
为了实现功率模块的更高工作温度,我们不断开发器件封装技术。表2显示了从传统封装到高温运行封装的技术。除了引进Ag烧结键合、耐高温绝缘基板、耐高温焊锡材料、电极US键合相关技术外,为支持高温运行功率模块的商业化,创新的封装设计、材料及制造工艺的开发是至关重要的。

表2:传统封装与高温运行封装的区别
今后,本公司将以多年积累的功率模块封装技术及量产技术为基础,加速开发新一代高温运行且高品质的功率模块,同时继续推进商业化,为实现环保及节能社会做出贡献。
正文完
<关于三菱电机>
三菱电机创立于1921年,是全球知名的综合性企业。截止2024年3月31日的财年,集团营收52579亿日元(约合美元348亿)。作为一家技术主导型企业,三菱电机拥有多项专利技术,并凭借强大的技术实力和良好的企业信誉在全球的电力设备、通信设备、工业自动化、电子元器件、家电等市场占据重要地位。尤其在电子元器件市场,三菱电机从事开发和生产半导体已有68年。其半导体产品更是在变频家电、轨道牵引、工业与新能源、电动汽车、模拟/数字通讯以及有线/无线通讯等领域得到了广泛的应用。
原文始发于微信公众号(三菱电机半导体):第15讲:高压SiC模块封装技术


